
Дизайн ІЦ, також відомий як дизайн інтегрованих схем, має високу точність у нанопроцесній технології, і чим більша точність, тим більш сучасний процес виробництва. Коли більше транзисторів інтегрується у процесор, чип може виконувати більше функцій, що безпосередньо зменшує вартість виробництва процесора. Але коли розміри процесних вузлів у інтегрованих схемах стають меншими, вимірювання критичних розмірів також стикається з величезними викликами. Вимірювання та аналіз геометричної морфологічної інформації, такої як період наноструктури, ширина лінії, висота лінії, кут бокової стіни та шorstкість, є екстремально важливим.
Рішення:
За допомогою вимірювання еліпсометрії матрицею Мюллера було отримано 16 наборів поляризаційної інформації, а також більш точні параметри еліпсометрії (PSI: співвідношення амплітуд, △: фазова різниця). Використовувалося кілька сотень вбудованих оптичних моделей для відповідності, після чого вимірювалась та аналізувалась геометрична форма наноструктур, така як період, ширина лінії, висота лінії, кут бокової стіни та шorstкість.
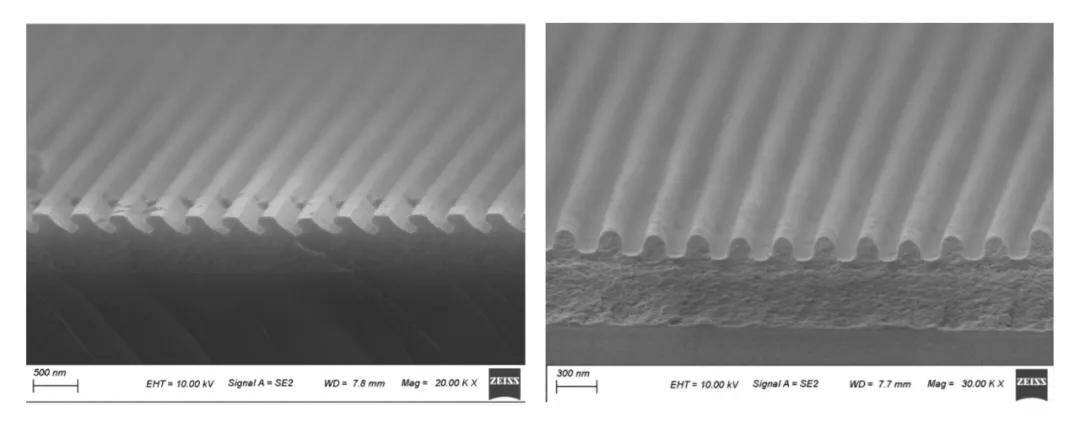
Створення оптичної моделі

Інформація про елемент поляризації



Авторське право © Гуанчжоу Minder-Hightech Co., Ltd. Всі права захищені