
Етчинг низкорозмірних матеріалів відноситься до процесу етчингу двовимірних матеріалів (на зразок графену, дисульфіду молібдену тощо) та одновимірних матеріалів (на зразок нанопровадків, нанотрубок тощо). Метою етчингу низкорозмірних матеріалів є підготовка наноструктур з певними формами та розмірами для досягнення керування та оптимізації властивостей матеріалів та продуктивності пристроїв. Низкорозмірні матеріали загалом етчуються за допомогою хімічних методів етчингу. Він використовує хімічні реакції для обробки матеріалів, а поширені хімічні методи етчингу включають мокрий етчинг та сухий етчинг.
Труднощі у фрезеруванні низкорозмірних матеріалів головним чином включають: 1. Вибір фрезерування: Різні низкорозмірні матеріали мають різні вимоги до умов фрезерування, і необхідно вибирати відповідні умови фрезерування на основі специфічних властивостей матеріалу, таких як газ для фрезерування, потужність, час тощо. 2. Якість фрезерування: Якість фрезерування низкорозмірних матеріалів напряму впливає на їхню продуктивність та застосування, і необхідно керувати швидкістю та глибиною фрезерування, щоб уникнути надмірного або недостатнього фрезерування. 3. Рівномірність фрезерування: Рівномірність фрезерування низкорозмірних матеріалів є ключовою для підготовки високоякісних пристроїв, і необхідно керувати параметрами, такими як температура, швидкість потоку газу та тиск під час процесу фрезерування, щоб забезпечити його рівномірність. 4. Обробка після фрезерування: Після фрезерування пробу необхідно очистити та обробити для видалення продуктів фрезерування та залишків газів фрезерування, щоб забезпечити якість поверхні та стійкість зразка.
Двовимірні електронні тонкі пленки матеріалів відносяться до нових двовимірних матеріалів з товщиною одного або декількох атомних шарів, які головним чином утворюються завдяки співвідносній зв'язкові.
Головним чином включає:
1. Графен, h-BN;
2. Оксиди перехідних металів;
3. TMCs, MX 2(M=Mo, W, Re, Ti, Zr, Hf, V, Nb, Ta, Pt, Pd, Fe; X=S, Se, Te), MoS 2, WS 2;тощо.
4. Часткові матеріали III/IV/V на основі сур'огу тощо.
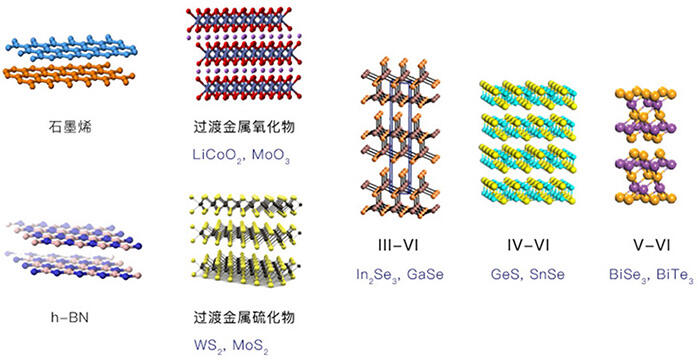
Ранні дослідження двовимірних електронних тонкісльових матеріалів, особливо графенних матеріалів, головним чином зосереджувалися на методах приготування двовимірних матеріалів, таких як механічне відшаровування, редукція, депозиція тощо, а також на дослідженні властивостей матеріалів. З постійними досягненнями у виготовленні великого розміру двовимірних тонких плівок, люди почали звертати увагу на виготовлення пристроїв. Зтовщення і патернізація двовимірних тонких плівок є ключовими для виготовлення двовимірних пристроїв. Традиційний напівпровідниковий плазменний сухий етching має два фатальні недоліки у зтовщенні і патернізації двовимірних матеріалів:
1. Надмірна швидкість етching не може задовольняти точному і стабільному етching атомних шарів 2D матеріалів (рівень під нанометр);
2. Висок енергійний іонний налет може призвести до структурних пошкоджень у 2D матеріалах, що викликає дефекти матеріалу
Характеристики, які машина для спеціального етчингу двовимірних матеріалів повинна мати, такі:
1. Контроль вихідної потужності на рівні міліватт;
2. Мінімальна початкова потужність повинна бути контролювана нижче 5W;
3. Контроль етчингу шар за шаром, зі швидкістю етчингу, яку можна точньо контролювати в діапазоні від 0.3 до 10 шарів на хвилину
4. Енергія іонів для бомбардування вибірки може бути як низькою, до 10 еВ або менше
розчин для етчингу двовимірних матеріалів - SHL 100 μ/200 μ - RIE
Ми розробили машину серії SHL 100 μ/200 μ - RIE на основі технології мікроплазми, щоб вирішити проблеми застосування патернів двовимірних матеріалів, зазначених вище. Машина використовується для етчингу зменшення шарів та патернового етчингу двовимірних матеріалів, таких як графен. Рисунок 2 показує зовнішній вигляд машини для етчингу двовимірних матеріалів.

Головні застосування машин для етчингу двовимірних матеріалів такі:
1. Етчинг відшарювання двовимірних матеріалів для підготовки вибірок двовимірних матеріалів з одним або декількома шарами
2. Інтерфейсна обробка 2D матеріалів для підготовки пристроїв на основі 2D матеріалів
3. Обробка модифікації 2D матеріалів
Основні показники продуктивності машини для етчингу двовимірних матеріалів:
1. Здатна обробляти зразки розміром до чотирьох/восьми дюймів і менше;
2. Суперслабкий плазменний етчинг: може досягнути процесної потужності як мінімум 3 В (@ 100мм електрод) RF (@ 13,56 МГц), з потужністю щільністю як мінімум 38 мВ/см2 та точністю вихідної потужності менше 0,1 В;
3. Енергія іонів для бомбардування вибірки може бути як низькою, як 10 еВ;
4. Вона може досягати стабільного і точного етчингу атомних шарів від 0,1 шару/хв до 1 шару/хв;
Головна конфігурація машини для етчингу двовимірних матеріалів така:
1. Її можна комплектувати 3-8 газами для процесу та цифрово керувати металевими запечатаними MFC;
2. Використання алюмінію семікондукторного класу 6061 як матеріалу для процесної камери, щоб вилучити забруднення вибірки шляхом примішування індивідуальних елементів з нержавіючих матеріалів;
3. Камера завантаження може бути налаштована, а вакуумний фон процесної камери може досягати 4 x 10-4 Па;
повна автоматична kontrolпроцесу, розподілена система входу користувача, реальне записування всієї процесної інформації та стану машини, управління бібліотекою процесних рецептів та їх виклику, управління циклом життя компонентів та самоперевірка несправностей.
графічні результати етчингу матеріалів 2D:
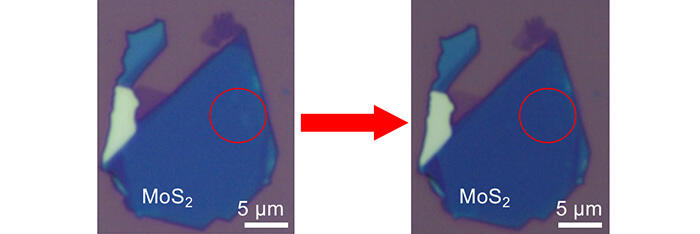
SHL100μ-RIE, 38 мВт/см 2, 10с: Очищення залишків на поверхні меншої кількості шарів відколотого MoS 2.
Від команди Сунь Цзянь та Лю Сяочі, Школи фізики та електроніки Центрального південної університету.

SHL100μ-RIE, 51 мВт/см 2, 3с: Еталонування МоS 2шар-за-шаром.
Від команди Сунь Цзянь та Лю Сяочі, Школи фізики та електроніки Центрального південної університету.
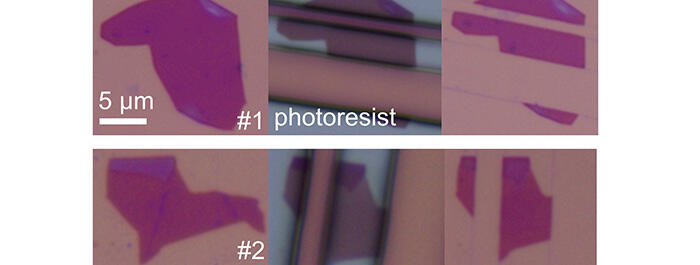
SHL100μ-RIE, 0.5 Вт/см 2: Шлифувати шар графену послойно.
Від команди Сунь Цзянь та Лю Сяочі, Школи фізики та електроніки Центрального південної університету.
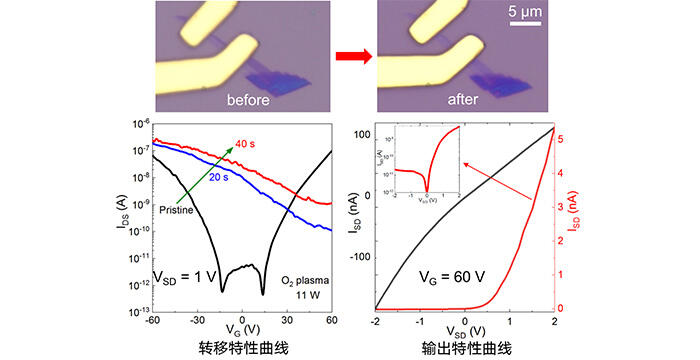
SHL100μ-RIE, 140 мВт/см 2: WSe 2p-тип допінг.
Від команди Сунь Цзянь та Лю Сяочі, Школи фізики та електроніки Центрального південної університету.
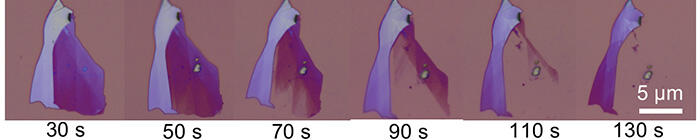
SHL100μ-RIE, 0.5 Вт/см 2: Шлифувати шар графену послойно.
Від команди Сунь Цзянь та Лю Сяочі, Школи фізики та електроніки Центрального південної університету.

SHL100μ-RIE, Шлифування WS 2шар-за-шаром.
Від команди Сюэфей Лі, Школи Хуацзуньського університету наук та технологій.
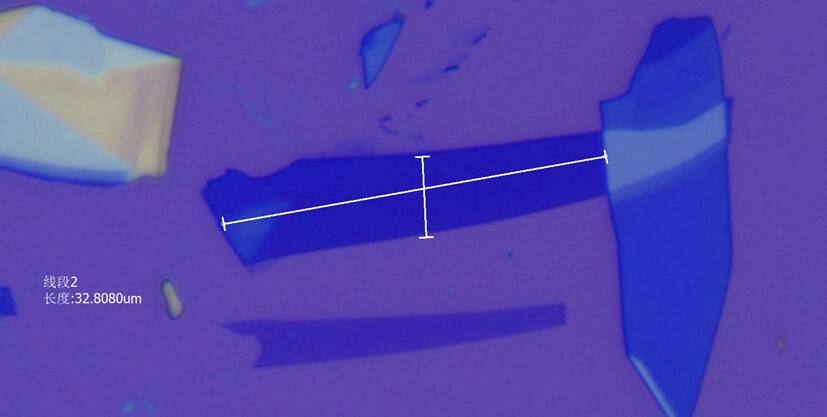
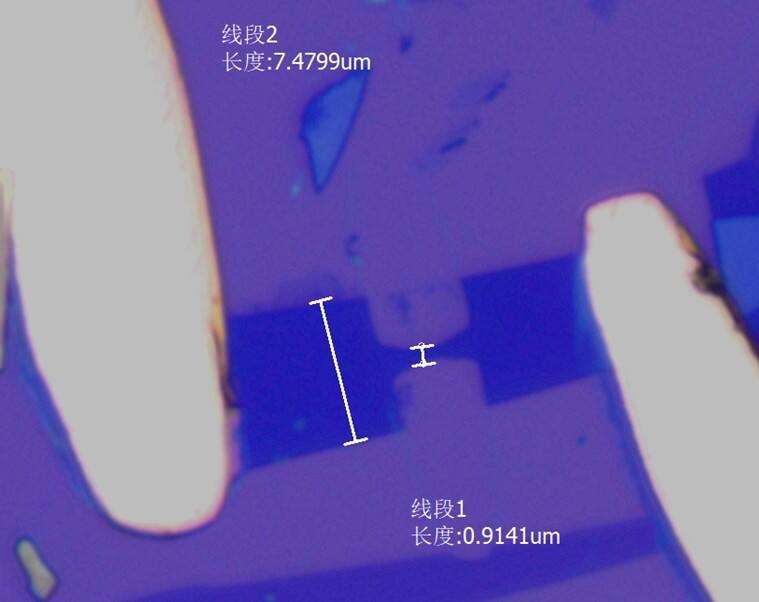
SHL100μ-RIE, Етчинг шаром за шаром графену.
Авторське право © Гуанчжоу Minder-Hightech Co., Ltd. Всі права захищені