
Этching низкоразмерных материалов относится к процессу травления двумерных материалов (например, графена, дисульфида молибдена и т. д.) и одномерных материалов (например, нанопроводников, нанотрубок и т. д.). Целью травления низкоразмерных материалов является создание наноструктур с определенными формами и размерами для достижения управления и оптимизации свойств материалов и характеристик устройств. Низкоразмерные материалы обычно травят с использованием химических методов травления. Он использует химические реакции для обработки материалов, и среди часто используемых химических методов травления выделяются влажное травление и сухое травление.
Трудности при травлении низкоразмерных материалов в основном включают: 1. Выбор травления: Разные низкоразмерные материалы имеют разные требования к условиям травления, и необходимо выбирать подходящие условия травления на основе конкретных свойств материала, таких как газ для травления, мощность, время и т.д. 2. Качество травления: Качество травления низкоразмерных материалов напрямую влияет на их характеристики и применение, и необходимо контролировать скорость и глубину травления, чтобы избежать чрезмерного или недостаточного травления. 3. Однородность травления: Однородность травления низкоразмерных материалов критически важна для создания высококачественных устройств, и необходимо контролировать параметры, такие как температура, скорость потока газа и давление во время процесса травления, чтобы обеспечить его однородность. 4. Послепроцессное травление: После травления образец нужно очистить и обработать для удаления продуктов травления и остаточных газов травления, что гарантирует качество поверхности и стабильность образца.
Двумерные электронные тонкопленочные материалы относятся к новым двумерным материалам с толщиной одного или нескольких атомных слоев, в основном образованным за счет ковалентного соединения.
Основные виды включают:
1. Графен, h-BN;
2. Оксиды металлов переходного ряда;
3. TMCs, MX 2(M=Mo, W, Re, Ti, Zr, Hf, V, Nb, Ta, Pt, Pd, Fe; X=S, Se, Te), MoS 2, WS 2;и др.
4. Частично III/IV/V сернокислые материалы и т.д.
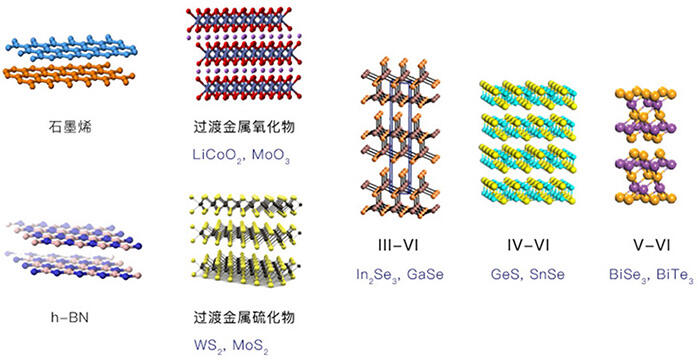
Ранние исследования двумерных электронных тонкопленочных материалов, особенно материалов графена,主要集中ались на методах получения двумерных материалов, таких как механическое отслоение, восстановление, напыление и т.д., а также изучении свойств материалов. С постоянными прорывами в производстве крупноформатных двумерных тонкопленочных материалов, люди начали обращать внимание на создание устройств. Тонирование и паттернирование двумерных тонкопленочных материалов являются ключевыми для создания двумерных устройств. Традиционный метод сухой плазменной гравировки полупроводников имеет два фатальных недостатка при тонировании и паттернировании двумерных материалов:
1. Избыточная скорость травления не может удовлетворить точному и стабильному травлению атомных слоев 2D-материалов (уровень субнанометра);
2. Высокоэнергетическое ионное облучение может вызывать структурные повреждения двумерных материалов, что приводит к дефектам материала
Характеристики, которыми должен обладать специализированный травильный станок для двумерных материалов, включают:
1. Контроль выходной мощности на уровне милливатт;
2. Минимальная начальная мощность должна контролироваться ниже 5 Вт;
3. Управление травлением слой за слоем, с скоростью травления, которая может точно регулироваться от 0,3 до 10 слоев в минуту
4. Энергия ионов для бомбардировки образца может быть столь низкой, как 10 эВ или менее
решение для травления двумерных материалов - SHL 100 μ/200 μ - RIE
На основе микроплазменной технологии мы разработали машину серии SHL 100 μ/200 μ - RIE для решения упомянутых выше проблем паттернирования двумерных материалов. Машина используется для уменьшения количества слоев и паттернированного травления двумерных материалов, таких как графен. На рисунке 2 показан внешний вид машины для травления двумерных материалов.

Основные применения машин для травления двумерных материалов включают:
1. Травление отслоения двумерных материалов для подготовки образцов из однослойных или немногослойных двумерных материалов
2. Гравировка узоров на материалах 2D для подготовки устройств из двумерных материалов
3. Обработка модификации двумерных материалов
Основные показатели производительности машины для гравировки двумерных материалов:
1. Может обрабатывать образцы размером до четырех/восьми дюймов и меньше;
2. Сверхмягкая плазменная гравировка: может достигать мощности процесса всего 3 Вт (@ 100 мм электрод) ВЧ (@ 13,56 МГц), с плотностью мощности всего 38 мВт/см² и точностью выходной мощности менее 0,1 Вт;
3. Энергия ионов для бомбардировки образца может быть столь низкой, как 10 эВ;
4. Она может обеспечивать стабильную и точную травлю атомного слоя от 0,1 слоя/мин до 1 слоя/мин;
Основная конфигурация машины для травления двумерных материалов включает:
1. Может быть оборудована от 3 до 8 процессных газов и цифровым управлением с металлически уплотнённым МФЦ;
2. Использование алюминия класса полупроводников 6061 в качестве материала процессной камеры для исключения загрязнения образца примесными элементами из нержавеющей стали;
3. Камера загрузочного замка может быть сконфигурирована, а вакуумный фон процессной камеры может достигать 4 x 10-4 Па;
полный автоматический контроль процесса, многоуровневое управление входом пользователя, реальное время записи всесторонних процессных данных и данных о состоянии машины, управление и вызов библиотеки процессов Recipe, управление жизненным циклом компонентов и самодиагностика неисправностей.
графические результаты машин для травления двумерных материалов:
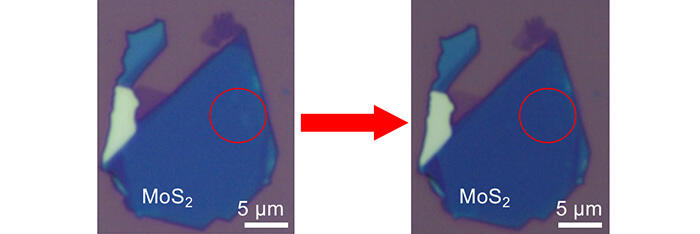
SHL100μ-RIE, 38 мВт/см 2, 10с: Очистка остатков на поверхности меньшего количества слоев отслоившегося MoS 2.
От команды Сунь Цзяня и Лю Сяочи, Школы физики и электроники Университета Центральной Южной провинции.

SHL100μ-RIE, 51 мВт/см 2, 3с: Этч MoS 2слой за слоем.
От команды Сунь Цзяня и Лю Сяочи, Школы физики и электроники Университета Центральной Южной провинции.
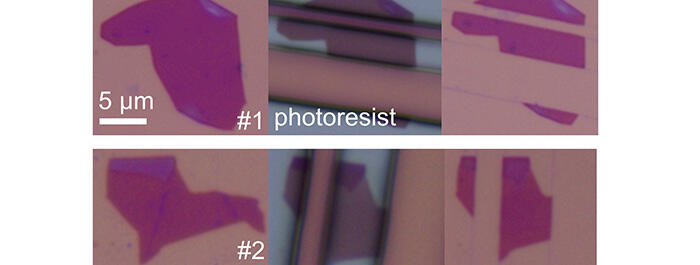
SHL100μ-RIE, 0.5 Вт/см 2: Этчинг слоя графена постепенно.
От команды Сунь Цзяня и Лю Сяочи, Школы физики и электроники Университета Центральной Южной провинции.
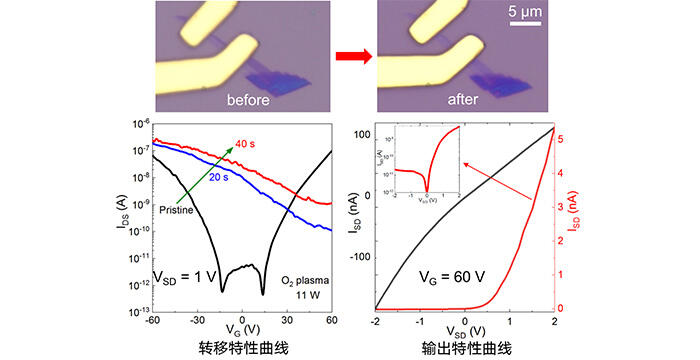
SHL100μ-RIE, 140 мВт/см 2: WSe 2n-тип допинг.
От команды Сунь Цзяня и Лю Сяочи, Школы физики и электроники Университета Центральной Южной провинции.
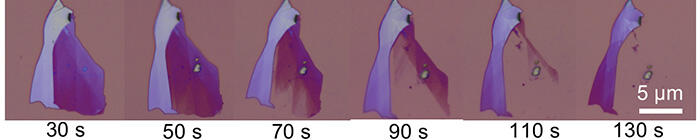
SHL100μ-RIE, 0.5 Вт/см 2: Этчинг слоя графена постепенно.
От команды Сунь Цзяня и Лю Сяочи, Школы физики и электроники Университета Центральной Южной провинции.

SHL100μ-RIE, Этчинг WS 2слой за слоем.
От команды Сюэфей Ли, Школы Университета науки и технологий Хуазхонг.
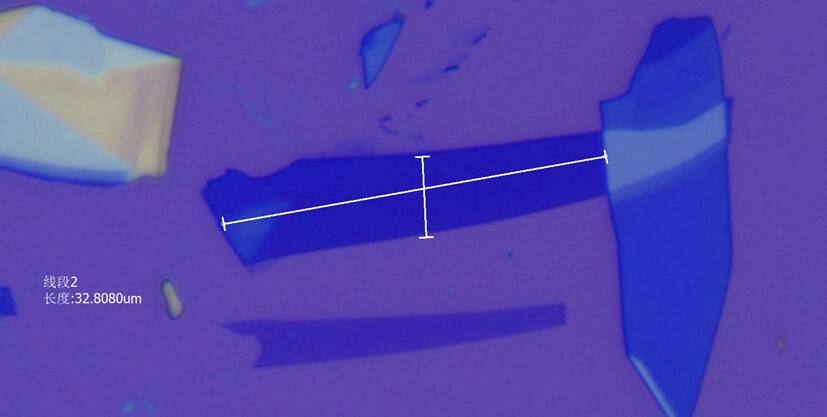
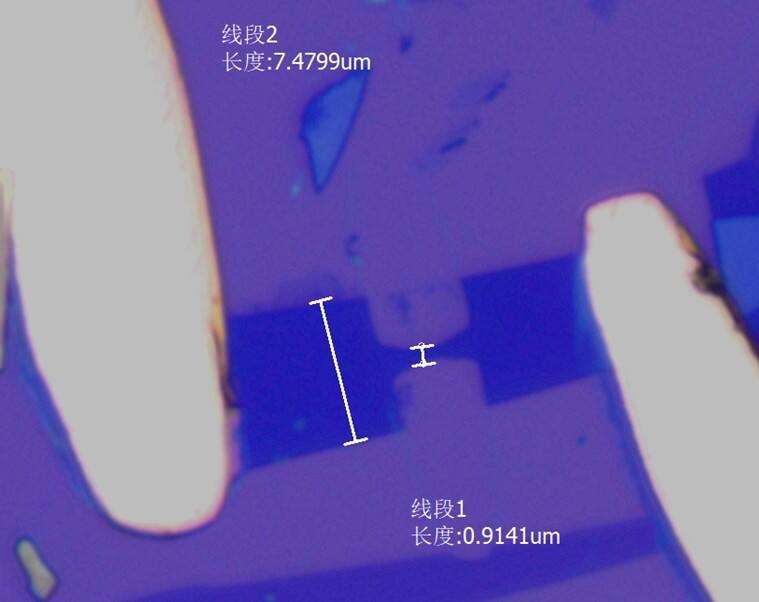
SHL100μ-RIE, Постройный травление графена.
Copyright © Guangzhou Minder-Hightech Co.,Ltd. Все права защищены