
Etching materiałów niskowymiarowych odnosi się do procesu etchingu dwuwymiarowych materiałów (takich jak grafen, disulfek molibdenu itp.) i jednowymiarowych materiałów (takich jak nanopręty, nanotruby itp.). Celem etchingu materiałów niskowymiarowych jest przygotowanie nanostruktur o określonych kształtach i rozmiarach w celu osiągnięcia kontroli i optymalizacji właściwości materiałów oraz wydajności urządzeń. Materiały niskowymiarowe są zazwyczaj etczowane za pomocą metod chemicznych. Wykorzystują one reakcje chemiczne do przetwarzania materiałów, a często stosowane metody chemicznego etchingu obejmują etching mokry i suchy.
Trudności związane z etczym materiałów niskowymiarowych obejmują przede wszystkim: 1. Wybór etczu: Różne materiały niskowymiarowe mają różne wymagania co do warunków etczu, a odpowiednie warunki muszą być wybrane na podstawie konkretnych właściwości materiału, takich jak gaz etczący, moc, czas itp. 2. Jakość etczu: Jakość etczu materiałów niskowymiarowych bezpośrednio wpływa na ich wydajność i zastosowania, dlatego konieczne jest kontrolowanie szybkości i głębokości etczu, aby uniknąć nadmiernego lub niewystarczającego etczu. 3. Jednolitość etczu: Jednolitość etczu materiałów niskowymiarowych jest kluczowa przy przygotowywaniu wysokiej jakości urządzeń, dlatego trzeba kontrolować parametry, takie jak temperatura, prędkość przepływu gazu i ciśnienie podczas procesu etczu, aby zapewnić jednolitość etczu. 4. Obsługa po etczu: Po etczu próbka musi zostać wyczyszczona i obsłużona, aby usunąć produkty etczu i pozostałe gazy etczące, co gwarantuje jakość powierzchni i stabilność próbki.
Materiały dwuwymiarowe elektroniczne w postaci cienkich warstw odnoszą się do nowych dwuwymiarowych materiałów o grubości jednego lub kilku atomów, które głównie powstają poprzez wiązania kowalencyjne.
Głównie obejmuje:
1. Grafen, h-BN;
2. Oksyd metali przejściowych;
3. TMCs, MX 2(M=Mo, W, Re, Ti, Zr, Hf, V, Nb, Ta, Pt, Pd, Fe; X=S, Se, Te), MoS 2, WS 2;itd.
4. Częściowo III/IV/V materiały siarkowe itp.
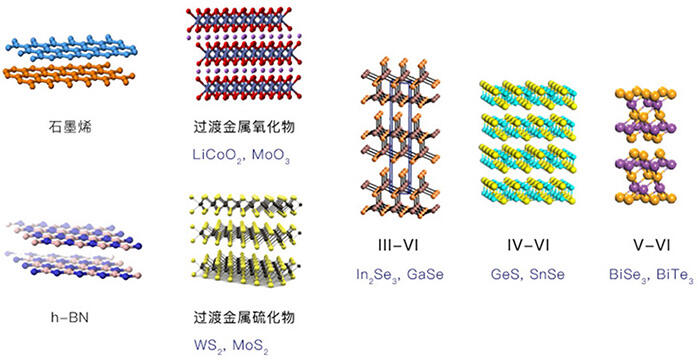
Wczesne badania nad dwuwymiarowymi materiałami elektronicznymi w postaci cienkich warstw, zwłaszcza materiałami grafenowymi, skupiały się przede wszystkim na metodach preparacji materiałów dwuwymiarowych, takich jak odizolowanie mechaniczne, redukcja, depozycja itp., oraz na badaniu ich właściwości. W miarę postępujących osiągnięć w produkcji dużych dwuwymiarowych cienkich warstw, zaczęto skupiać uwagę na przygotowywaniu urządzeń. Cieniowanie i wzorowanie dwuwymiarowych cienkich warstw są kluczowe w procesie tworzenia urządzeń dwuwymiarowych. Tradycyjna metoda plazmowego suchego etczowania półprzewodników ma dwa fatalne wady w kontekście cienienia i wzorowania materiałów dwuwymiarowych:
1. Zbyt wysoka szybkość etczowania nie odpowiada precyzyjnej i stabilnej etcytacji warstw atomowych materiałów 2D (poziom podnanometrowy);
2. Wysokoenergetyczne bombardowanie jonami może spowodować uszkodzenia strukturalne materiałów 2D, powodując defekty materiału
Cechy, jakie powinien posiadać fachowy aparat do etczynienia materiałów dwuwymiarowych to:
1. Sterowanie mocą wyjściową na poziomie miliwatów;
2. Minimalna moc początkowa powinna być kontrolowana poniżej 5W;
3. Kontrolowane etczynienie warstwa po warstwie, z szybkością etczynienia, która może być precyzyjnie kontrolowana między 0,3 a 10 warstwami na minutę
4. Energetyczność jonów przy bombardowaniu próbki może wynosić zaledwie 10 eV lub mniej
rozwiązanie do etczowania materiałów 2D - SHL 100 μ/200 μ - RIE
Na podstawie technologii mikroplazmy opracowaliśmy maszynę serii SHL 100 μ/200 μ - RIE, aby rozwiązać wspomniane wyżej problemy związane z aplikacjami w zakresie wzorcowania materiałów dwuwymiarowych. Maszyna ta służy do etczowania redukującego warstwy oraz do wzorcowego etczowania materiałów dwuwymiarowych, takich jak grafen. Rysunek 2 przedstawia wygląd maszyny do etczowania materiałów dwuwymiarowych.

Główne zastosowania maszyn do etczowania materiałów dwuwymiarowych to:
1. Etczowanie odwarstwienia materiałów 2D w celu przygotowania próbek materiałów dwuwymiarowych jednowarstwowych lub kilkuwarstwowych
2. Wycinanie wzorów na materiałach 2D w celu przygotowania urządzeń z materiałów 2D
3. Modyfikacja przetwarzania materiałów 2D
Podstawowe wskaźniki wydajności maszyny do wycinania materiałów dwuwymiarowych:
1. Może obsługiwać próbki o rozmiarze do czterech/czterech cali i mniejszych;
2. Ultra słabe wycinanie plazmowe: Osiąga moc procesu aż 3 W (@ elektroda 100mm) RF (@ 13,56 MHz), z gęstością mocy aż 38 mW/cm2 i dokładnością wyjściowej mocy poniżej 0,1 W;
3. Energetyczne jonów używanych do bombardowania próbki może wynosić zaledwie 10 eV;
4. Pozwala na stabilne i precyzyjne etczowanie warstwy atomowej od 0,1 warstwy/min do 1 warstwy/min;
Główne rozwiązanie konstrukcyjne maszyny do etczowania materiałów dwuwymiarowych to:
1. Może być wyposażona w 3 do 8 gazów procesowych i cyfrowo kontrolowana za pomocą hermetycznego MFC z metalem;
2. Używanie stopu aluminium 6061 klasy półprzewodnikowej jako materiału komory procesowej, aby wyeliminować zanieczyszczenie próbki przez elementy obce w materiałach z nierdzewnej stali;
3. Komora blokująca obciążenie może być skonfigurowana, a tło próżni w komorze procesowej może osiągnąć 4 x 10-4 Pa;
pełne automatyczne sterowanie procesem, hierarchiczne zarządzanie logowaniem użytkowników, rzeczywiste rejestrowanie kompleksowych danych procesowych i danych statusowych maszyny, zarządzanie i wywoływanie biblioteki procesów Recipe, zarządzanie cyklem życia elementów oraz samodiagnoza awarii.
graficzne wyniki maszyny do etczowania materiałów 2D:
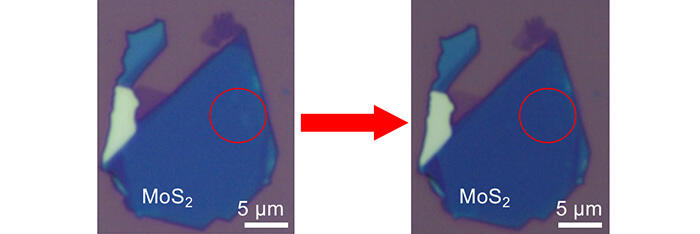
SHL100μ-RIE, 38 mW/cm 2, 10s: Czyszczenie resztek na powierzchni mniejszej liczby warstw odprysku MoS 2.
Od zespołu Sun Jiana i Liu Xiaochiego, Szkoły Fizyki i Elektroniki Uniwersytetu Środkowo-Jużnego.

SHL100μ-RIE, 51 mW/cm 2, 3s: Etcz MoS 2warstwa po warstwie.
Od zespołu Sun Jiana i Liu Xiaochiego, Szkoły Fizyki i Elektroniki Uniwersytetu Środkowo-Jużnego.
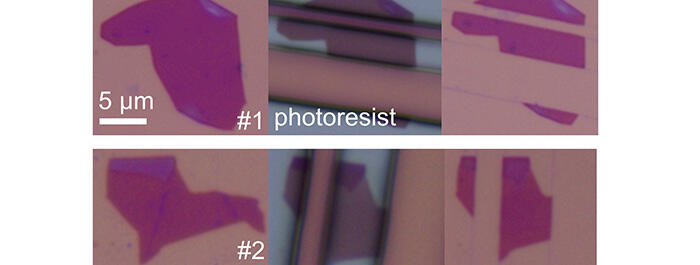
SHL100μ-RIE, 0.5 W/cm 2: Etczowanie warstwy grafenu po warstwie.
Od zespołu Sun Jiana i Liu Xiaochiego, Szkoły Fizyki i Elektroniki Uniwersytetu Środkowo-Jużnego.
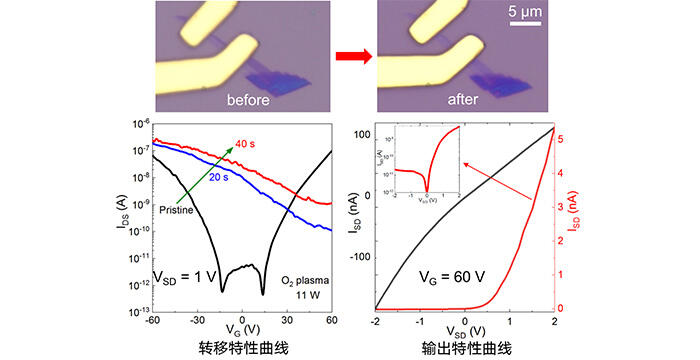
SHL100μ-RIE, 140 mW/cm 2: WSe 2dopowanie p-typu.
Od zespołu Sun Jiana i Liu Xiaochiego, Szkoły Fizyki i Elektroniki Uniwersytetu Środkowo-Jużnego.
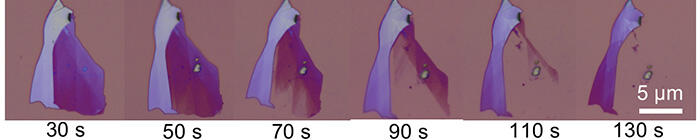
SHL100μ-RIE, 0.5 W/cm 2: Etczowanie warstwy grafenu po warstwie.
Od zespołu Sun Jiana i Liu Xiaochiego, Szkoły Fizyki i Elektroniki Uniwersytetu Środkowo-Jużnego.

SHL100μ-RIE, Etczowanie WS 2warstwa po warstwie.
Od zespołu Xuefei Li, Szkoła Politechniki Naukowej i Technologicznej Huazhong.
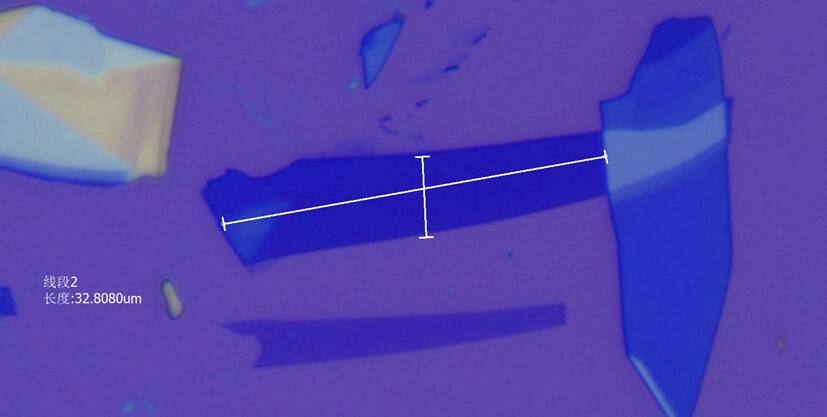
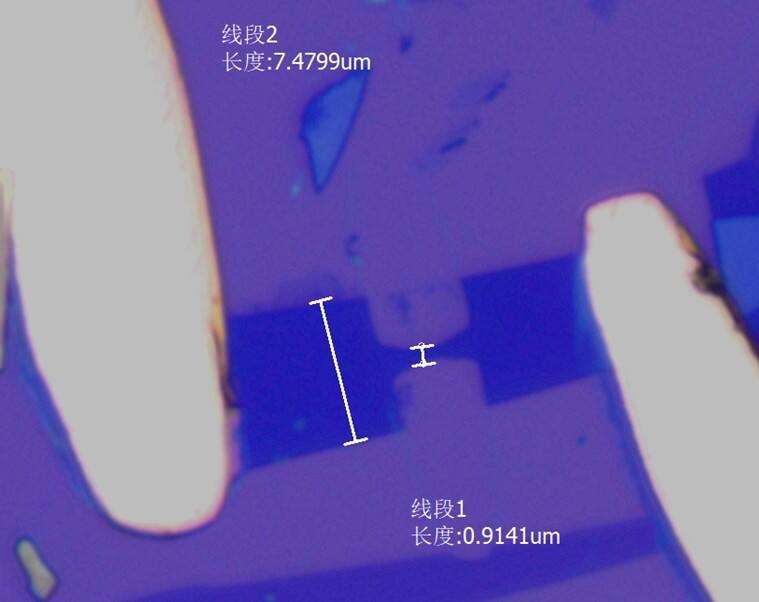
SHL100μ-RIE, Etch warstwa po warstwie grafenu.
Copyright © Guangzhou Minder-Hightech Co.,Ltd. Wszelkie prawa zastrzeżone