
IC დიზაინი, რომელსაც სხვას უწოდებენ ინტეგრირებული წრედის დიზაინი, მაღალი ზუსტობას ჰქონდება ნანო პროცესური ტექნოლოგიაში, და საკმარისია ზუსტობა მეტი იქნება, მეტად განვითარებული იქნება წარმოების პროცესი. როდესაც მეტი ტრანზისტორი ინტეგრირებულია პროცესორში, ჩიპი შეძლებს მეტი ფუნქცია ასრულებს, რაც პრინციპულად დაბალავს პროცესორის წარმოების ღირებულებას. მაგრამ როგორც ინტეგრირებული წრეების პროცესური ნოდები პატარა ხდება, კრიტიკული ზომების ზომვაც მიენახავს დიდ გამოწვევებს. ნანოსტრუქტურის პერიოდი, ხაზის სიგანე, ხაზის სიმაღლე, მხარე კუთხე და გამოწვევას ზომავა და ანალიზი გეომეტრიული მორფოლოგიის ინფორმაციას მთავრობს.
Ამოხსნა:
Mueller მატრიცის ელიფსომეტრიული ზომვით, მიღებულია 16 ნაკრები პოლარიზაციის ინფორმაცია, და მიღებულია უფრო ზუსტი ელიფსომეტრიული პარამეტრები (PSI: ამპლიტუდის გარშემო, △: ფაზის განსხვავება). გამოყენებულია ათასი ჩაშენებული ოპტიკური მოდელი მოწყობილებისთვის, და შემდეგ გამოмерილი და ანალიზი გაიარეს გეომეტრიული ფორმის ინფორმაცია, როგორიცაა ნანოსტრუქტურის პერიოდი, ხაზის სიგანე, ხაზის სიმაღლე, მხარე კუთხე და გამოტანილობა.
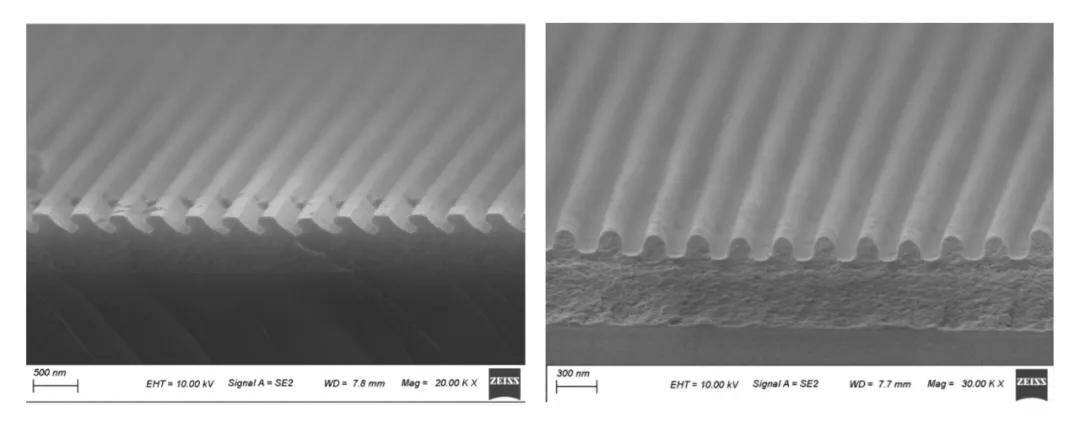
Დამყარების მოდელის დამყარება

Პოლარიზაციის ელემენტების ინფორმაცია



Საავტორო უფლება © Guangzhou Minder-Hightech Co.,Ltd. ყველა უფლება დაცულია