
Etching af lavdimensionelle materialer henviser til processen med at grave to-dimensionelle materialer (som f.eks. grafen, molybdæn disulfid osv.) og en-dimensionelle materialer (som f.eks. nanotråde, nanorør osv.). Formålet med etching af lavdimensionelle materialer er at forberede nanostrukturer med bestemte former og størrelser for at opnå kontrol og optimering af materialeegenskaber og enhedsydeevne. Lavdimensionelle materialer gravies normalt ved hjælp af kemisk etchingsmetoder. Den bruger kemiske reaktioner til at behandle materialerne, og de mest almindelige kemiske etchingsmetoder omfatter vådetching og tørretching.
De vanskeligheder ved at grave lavdimensionelle materialer omfatter hovedsagelig: 1. Gravevalg: Forskellige lavdimensionelle materialer har forskellige krav til gravebetingelser, og passende gravebetingelser skal vælges ud fra materialets specifikke egenskaber, såsom gravegas, magt, tid osv. 2. Gravekvalitet: Gravekvaliteten af lavdimensionelle materialer påvirker direkte deres ydeevne og anvendelighed, og det er nødvendigt at kontrollere gravhastigheden og dybden for at undgå overdreven eller utilstrækkelig gravning. 3. Graveensartethed: Graveensartetheden af lavdimensionelle materialer er afgørende for at forberede høj-kvalitets enheder, og det er nødvendigt at kontrollere parametre som temperatur, gasstrøm og tryk under gravningsprocessen for at sikre graveensartethed. 4. Eftergravbehandling: Efter gravning skal prøven rengøres og behandles for at fjerne graveprodukter og rester af gravegasser, hvilket sikrer overflade-kvaliteten og stabilitten af prøven.
To-dimensionelle elektroniske tynde filmsmaterialer henviser til nye to-dimensionelle materialer med enkelte eller få atomlag tykkelse, hovedsagelig dannet af kovalente bindinger.
Hovedsagelig inkluderer:
1. Graphen, h-BN;
2. Overgangsmetalloxider;
3. TMC'er, MX 2(M=Mo, W, Re, Ti, Zr, Hf, V, Nb, Ta, Pt, Pd, Fe; X=S, Se, Te), MoS 2, WS 2;osv.
4. Del III/IV/V svovl-baserede materialer mv.
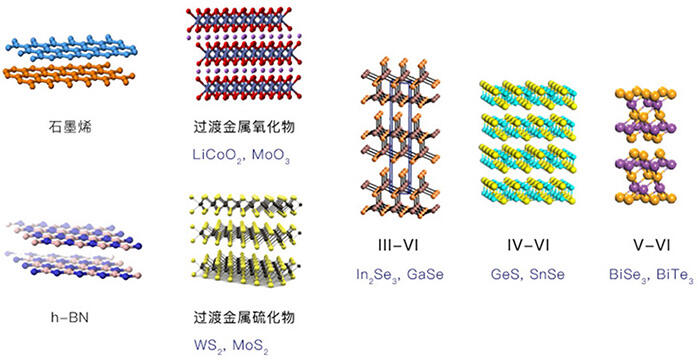
Tidlig forskning inden for to-dimensionelle elektroniske tyndfilmmaterialer, især grafenmaterialer, fokuserede hovedsageligt på fremgangsmåderne til at forberede to-dimensionelle materialer, såsom mekanisk afskæling, reduktion, afsetting mv., samt studiet af materialeegenskaber. Med de kontinuerlige gennembrud i forberedelsen af store to-dimensionelle tyndfilmmaterialer har mennesker begyndt at vende deres opmærksomhed mod fremstillingen af enheder. Tyndning og mønstre af to-dimensionelle tyndfilmmaterialer er nøglen til fremstillingen af to-dimensionelle enheder. Den traditionelle halvlederplasmadørret grave metode har to afgørende ulemper ved tyndning og mønstre af to-dimensionelle materialer:
1. For høj gravehastighed kan ikke opfylde kravene til nøjagtig og stabil grave af 2D-materialers atomlag (sub nanometer niveau);
2. Højenergi jonbombering kan forårsage strukturel skade på 2D-materialer, hvilket resulterer i materialefejl
De karakteristika, en specialiseret gravevaskemaskine til to-dimensionelle materialer bør have, er:
1. Kontrollér udgangs effekten på milliwatt-niveau;
2. Den minimale starteffekt skal kontrolleres under 5W;
3. Lag for lag grave kontrol, med en gravhastighed, der kan præcist kontrolleres mellem 0,3 og 10 lag pr. minut
4. Ionenergien til bombardering af prøven kan være så lav som 10 eV eller mindre
løsning til 2D-materiale-etching - SHL 100 μ/200 μ - RIE
Vi har udviklet maskinen i SHL 100 μ/200 μ - RIE-serien baseret på mikroplasmateknologi for at løse de anvendelsesmæssige problemstillinger vedrørende mønsterfremstilling af to-dimensionale materialer, der er nævnt ovenfor. Maskinen bruges til lagreduktion og mønsteretcing af to-dimensionale materialer såsom graphene. Figur 2 viser udsigten af maskinen til etching af to-dimensionale materialer.

De primære anvendelser af to-dimensionale materialeetchingsmaskiner er:
1. Etching af delaminering af 2D-materialer for at forberede enkeltslags- eller fåslags-2D-materialeprøver
2. Graveringsproces for 2D-materiale mønstre for at forberede 2D-materialer
3. Bearbejdning af 2D-materialemodifikation
Kerneydelsesparametre for maskine til gravering af to-dimensionalt materiale:
1. Kan behandle prøver op til fire tommer/åtte tommer og mindre i størrelse;
2. Ultra svag plasma-gravering: Den kan opnå en procesmagt så lav som 3 W (@ 100mm elektrode) RF (@ 13,56 MHz), med en magttæthed så lav som 38 mW/cm2 og en udgangsmagtpræcision på mindre end 0,1 W;
3. Ionenergien til bombardering af prøven kan være så lav som 10 eV;
4. Den kan opnå stabil og præcis atomlag-etsning fra 0,1 lag/min til 1 lag/min;
Hovedkonfigurationen af maskinen til etching af to-dimensionale materialer er:
1. Den kan konfigureres med 3 til 8 procesgasser og digitalt styres med metalforlukket MFC;
2. Ved brug af semiconductorgrads 6061 aluminium som proceskammermateriale for at eliminere forurening af prøven af sporelementer i rostfrit stål;
3. Indlæsningskammeret kan konfigureres, og baggrundsvakuoen i proceskammeret kan nå 4 x 10-4 Pa;
fuld automatisk processtyring, gradueret brugerloginforvaltning, realtidsoptagelse af omfattende procesdata og maskinstatusdata, opbevaring og kald af processbibliotek, komponentlivscyklusforvaltning og fejlselvdiagnose.
grafiske resultater for etchmaskine til 2D-materialer:
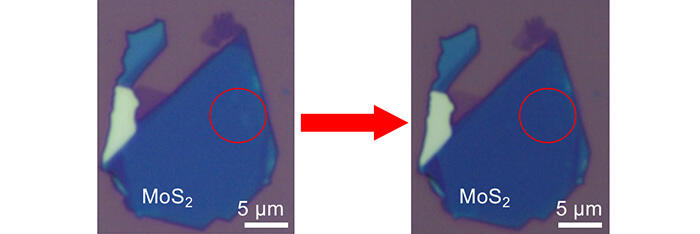
SHL100μ-RIE, 38 mW/cm 2, 10s: Rengør rester på overfladen af færre lag flået MoS 2.
Fra Sun Jian & Liu Xiaochi Team, School of Physics and Electronics of Central South University.

SHL100μ-RIE, 51 mW/cm 2, 3s: Etcher MoS 2lag for lag.
Fra Sun Jian & Liu Xiaochi Team, School of Physics and Electronics of Central South University.
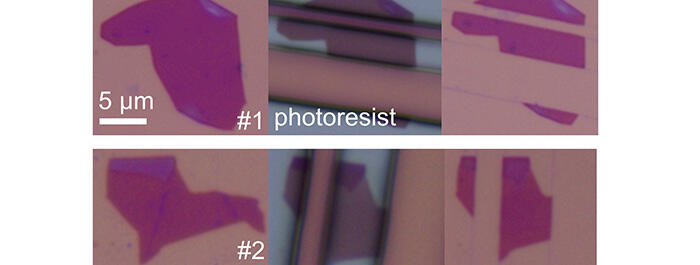
SHL100μ-RIE, 0.5 W/cm 2: Etch Graphene lag-for-lag.
Fra Sun Jian & Liu Xiaochi Team, School of Physics and Electronics of Central South University.
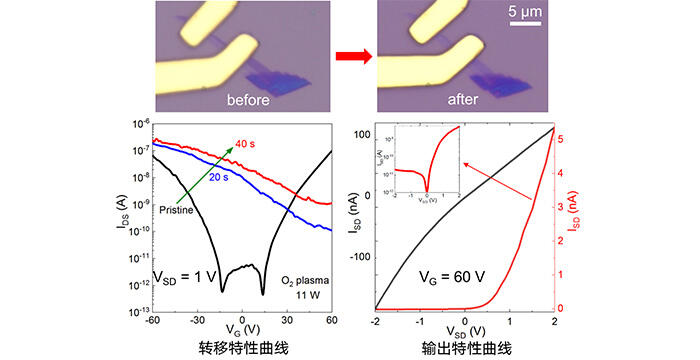
SHL100μ-RIE, 140 mW/cm 2: WSe 2p-Type doping.
Fra Sun Jian & Liu Xiaochi Team, School of Physics and Electronics of Central South University.
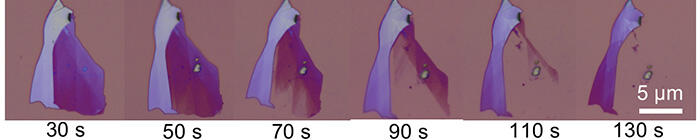
SHL100μ-RIE, 0.5 W/cm 2: Etch Graphene lag-for-lag.
Fra Sun Jian & Liu Xiaochi Team, School of Physics and Electronics of Central South University.

SHL100μ-RIE, Etch WS 2lag for lag.
Fra Xuefei Li Team, School of Huazhong University of Science and Technology.
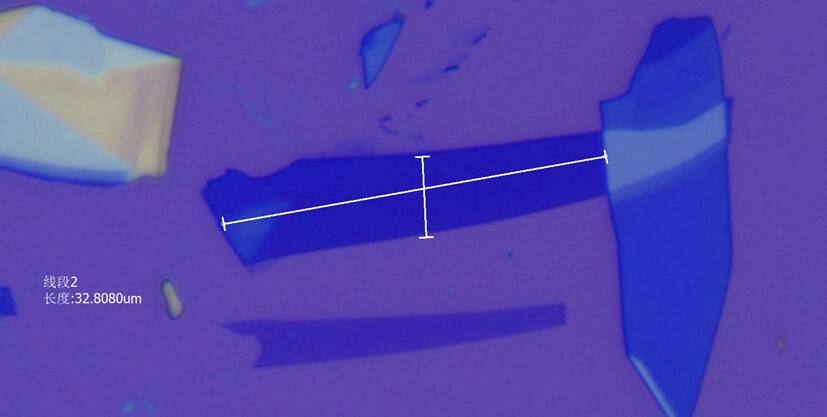
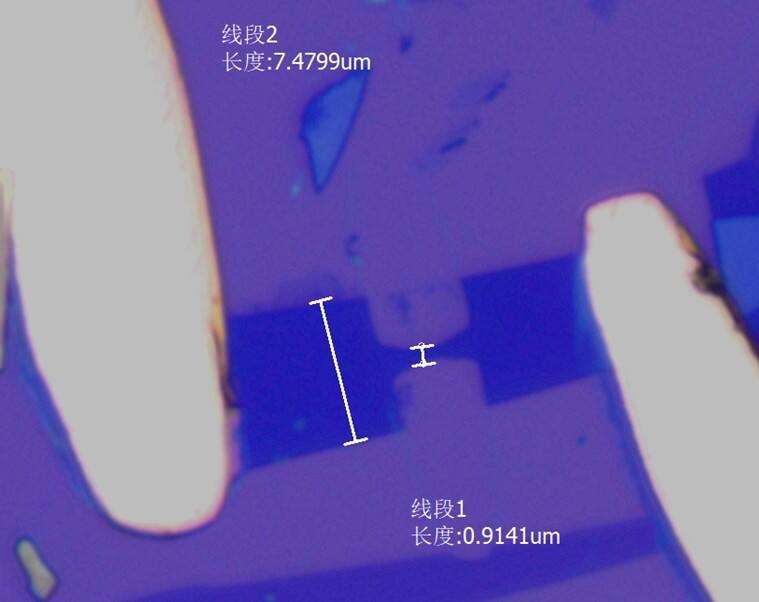
SHL100μ-RIE, Etch Graphene lag for lag.
Copyright © Guangzhou Minder-Hightech Co.,Ltd. Alle rettigheder forbeholdes