
Etching nízko-rozměrného materiálu se týká procesu gravování dvourozměrných materiálů (jako je grafén, disulfid molibdenu atd.) a jednorozměrných materiálů (jako jsou nanovlákniny, nanotrubičky atd.). Cílem etchingu nízko-rozměrného materiálu je připravit nanostruktury s konkrétními tvary a velikostmi, aby bylo možné dosáhnout řízení a optimalizace vlastností materiálu a výkonu zařízení. Nízko-rozměrné materiály jsou obvykle gravovány pomocí chemických metod etchingu. Používá chemické reakce k zpracování materiálů a běžně používané chemické metody etchingu zahrnují mokrou a suchou erozi.
Těžkosti související s gravováním nízko-rozměrných materiálů zahrnují především: 1. Výběr gravování: Různé nízko-rozměrné materiály mají různé požadavky na podmínky gravování a je třeba vybrat vhodné podmínky gravování v závislosti na konkrétních vlastnostech materiálu, jako jsou gravovační plyny, výkon, čas atd. 2. Kvalita gravování: Kvalita gravování nízko-rozměrných materiálů přímo ovlivňuje jejich vlastnosti a aplikace a je nutné řídit rychlost a hloubku gravování, aby se zabránilo přehnanému nebo nedostatečnému gravování. 3. Rovnoměrnost gravování: Roynoměrnost gravování nízko-rozměrných materiálů je klíčová pro přípravu vysokokvalitních zařízení a je nutné řídit parametry, jako jsou teplota, rychlost průtoku plynu a tlak během procesu gravování, aby se zajistila rovnoměrnost gravování. 4. Zpracování po gravování: Po gravování je nutné vzorek vyčistit a zpracovat, aby se odstranily produkty gravování a zbylé gravovační plyny, což zajistí kvalitu povrchu a stabilitu vzorku.
Dvourozměrné elektronické tenkofilmové materiály odkazují na nové dvourozměrné materiály s tloušťkou jednoho nebo několika atomových vrstev, které jsou převážně tvořeny kovalentními vazbami.
Hlavně zahrnuje:
1. Grafén, h-BN;
2. Oxydy přechodných kovů;
3. TMCs, MX 2(M=Mo, W, Re, Ti, Zr, Hf, V, Nb, Ta, Pt, Pd, Fe; X=S, Se, Te), MoS 2, WS 2;atd.
4. Parciální materiály založené na síre III/IV/V atd.
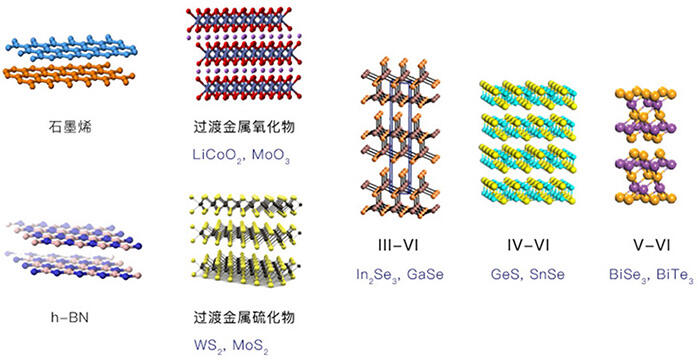
Předchozí výzkum dvourozměrných elektronických tenkofilmových materiálů, zejména uhlíkových materiálů graphene, se soustředil především na metody přípravy dvourozměrných materiálů, jako je mechanické odštípávání, redukce, depositace atd., a také na studium vlastností materiálů. S neustálými průlomy v přípravě velkého množství dvourozměrných tenkofilmových materiálů začali lidé uplatňovat pozornost na přípravu zařízení. Tenčení a formování vzorů dvourozměrných tenkofilmových materiálů jsou klíčem k přípravě dvourozměrných zařízení. Tradiční semikonduktorská plazmatická suchá etalace má ve dvou oblastech fatální nedostatky:
1. Příliš vysoká rychlost etalace nemůže splnit přesné a stabilní etalaci atomových vrstev 2D materiálů (subnanometrická úroveň);
2. Vysokoenérgetická iontová bombaďování může způsobit strukturální poškození 2D materiálů, což vede k defektům materiálu
Vlastnosti, které by měla mít speciální odrážecí stroj pro dvourozměrné materiály, jsou:
1. Ovládat výstupní výkon na úrovni miliwattů;
2. Minimální spouštěcí výkon by měl být ovládán pod 5W;
3. Ovládání odrážení vrstvu po vrstvě, s mírou odrážení, která lze přesně ovládat mezi 0,3 a 10 vrstvami za minutu
4. Energie iontů pro bombardování vzorku může být až 10 eV nebo méně
řešení na etching 2D materiálů - SHL 100 μ/200 μ - RIE
Vyvinuli jsme zařízení SHL 100 μ/200 μ - RIE na základě mikroplazmové technologie, aby byly vyřešeny problémy s aplikacemi při vytváření vzorů na dvoudimenzionálních materiálech uvedené výše. Toto zařízení se používá pro redukci vrstev při etchingu a pro strukturovaný etching dvoudimenzionálních materiálů, jako je grafén. Obrázek 2 ukazuje vzhled stroje na etching dvoudimenzionálních materiálů.

Hlavní aplikace strojů na etching dvoudimenzionálních materiálů jsou:
1. Etching oddělení 2D materiálů pro přípravu vzorků jednovrstvého nebo několikavrstvého 2D materiálu
2. Vyřezávání vzorů 2D materiálů pro přípravu zařízení z 2D materiálů
3. Úprava zpracování 2D materiálů
Hlavní výkonnostní ukazatele stroje na vyřezávání dvourozměrných materiálů:
1. Dokáže zpracovat vzorky o velikosti až čtyř palců/osmi palců a menší;
2. Ultra slabé plazmové vyřezávání: Dokáže dosáhnout výkonu procesu až 3 W (@ 100mm elektroda) RF (@ 13,56 MHz), s hustotou výkonu až 38 mW/cm2 a přesností výstupního výkonu méně než 0,1 W;
3. Energie iontů pro bombardování vzorku může být až 10 eV;
4. Dokáže dosahovat stabilní a přesnou etčení atomové vrstvy od 0,1 vrstvy/min do 1 vrstvy/min;
Hlavní konfigurace stroje na etčení dvourozměrných materiálů je:
1. Lze ho vybavit 3 až 8 procesními plyny a digitálně ovládat kovově uzavřeným MFC;
2. Používá se polovodičová kvalita 6061 hliníku jako materiál pro procesní komoru, aby se eliminovalo kontaminace vzorku cizími prvky v kovových materiálech;
3. Komora náboje může být nakonfigurována a pozadová vakuum v procesní komoře může dosáhnout 4 x 10-4 Pa;
plně automatická kontrola procesu, hierarchické přihlašování uživatelů, reálně časové záznamy detailních dat procesu a stavových dat stroje, správa a volání knihovny procesních receptur, manažerská data životnosti součástí a samodiagnostika poruch.
grafické výsledky mašiny na etching 2D materiálů:
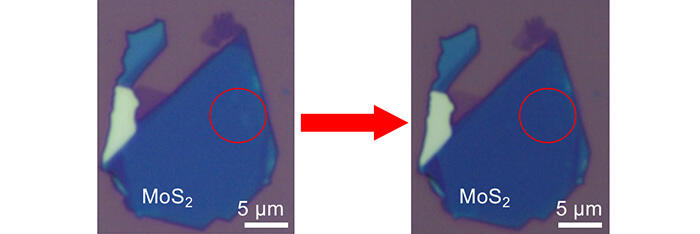
SHL100μ-RIE, 38 mW/cm 2, 10s: Čištění reziduí na povrchu málovrstvého exfoliového MoS 2.
Od týmu Sun Jian a Liu Xiaochi, Fakulty fyziky a elektroniky Jihočínské univerzity.

SHL100μ-RIE, 51 mW/cm 2, 3s: Vyřezávání MoS 2vrstva po vrstvě.
Od týmu Sun Jian a Liu Xiaochi, Fakulty fyziky a elektroniky Jihočínské univerzity.
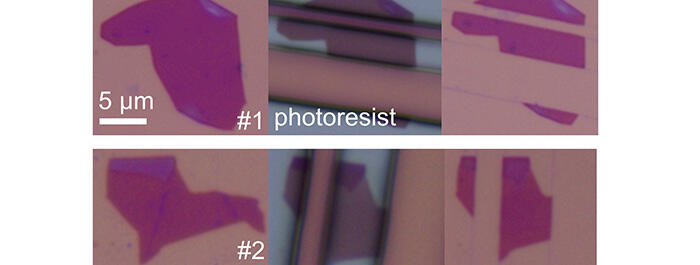
SHL100μ-RIE, 0.5 W/cm 2: Etčuj vrstvu grafenu postupně.
Od týmu Sun Jian a Liu Xiaochi, Fakulty fyziky a elektroniky Jihočínské univerzity.
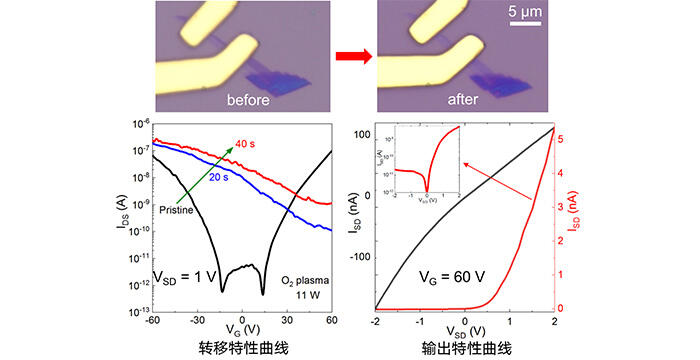
SHL100μ-RIE, 140 mW/cm 2: WSe 2p-Typ dovolení.
Od týmu Sun Jian a Liu Xiaochi, Fakulty fyziky a elektroniky Jihočínské univerzity.
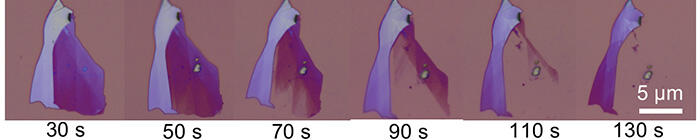
SHL100μ-RIE, 0.5 W/cm 2: Etčuj vrstvu grafenu postupně.
Od týmu Sun Jian a Liu Xiaochi, Fakulty fyziky a elektroniky Jihočínské univerzity.

SHL100μ-RIE, Etčuj WS 2vrstva po vrstvě.
Od týmu Xuefei Li, Fakulta Huazhongské univerzity vědy a techniky.
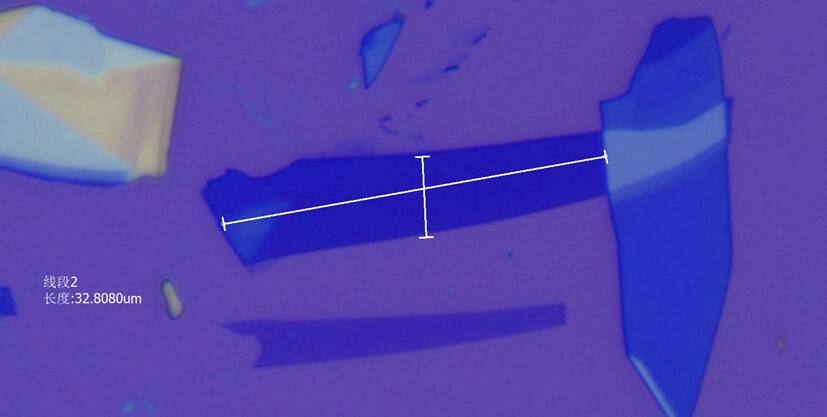
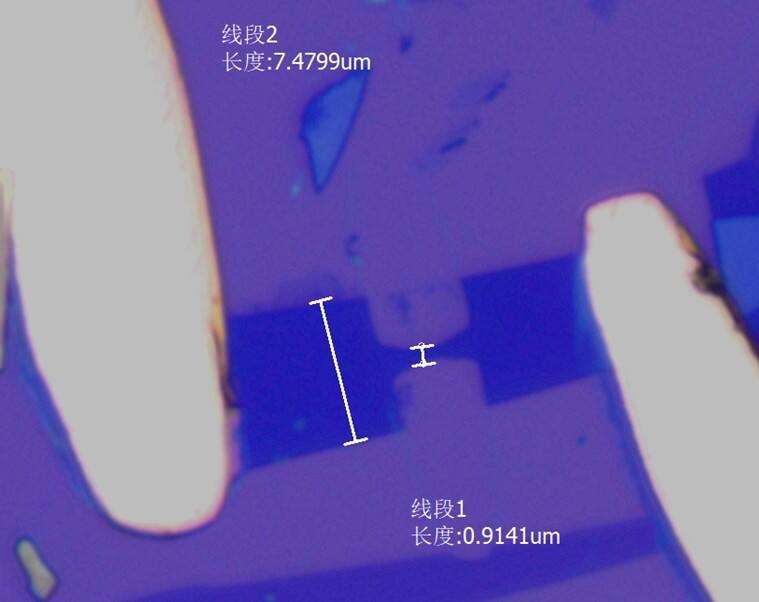
SHL100μ-RIE, Vyřezávání vrstvy grafenu po vrstvách.
Copyright © Guangzhou Minder-Hightech Co.,Ltd. Všechna práva vyhrazena