
Ang pag-eetch ng material na may mababang dimensyon ay tumutukoy sa proseso ng pag-eetch ng mga materyales na dalawang-dimensyonal (tulad ng graphene, molybdenum disulfide, atbp.) at isa-dimensyonal na mga materyales (tulad ng nanowires, nanotubes, atbp.). Ang layunin ng pag-eetch ng material na may mababang dimensyon ay maghanda ng mga nano-istraktura na may tiyak na anyo at sukat upang makamit ang kontrol at optimisasyon ng mga katangian ng materyales at pagganap ng device. Pangkalahatan, ginagamit ang mga paraan ng kimikal na pag-eetch sa pagsasakop ng mga materyales na ito. Gumagamit ito ng mga reaksyon kimikal upang iproseso ang mga materyales, at ang mga karaniwang ginagamit na paraan ng kimikal na pag-eetch ay kasama ang wet etching at dry etching.
Ang mga hamon sa pag-eetch ng mga materyales na may mababang dimensional ay kabilang sa mga sumusunod: 1. Pagsasalin ng eetching: May iba't ibang kinakailangang kondisyon ng eetching para sa bawat uri ng materyales na may mababang dimensional, at kinakailangan pumili ngkopong kondisyon ng eetching batay sa partikular na katangian ng materyales, tulad ng gas na ginagamit sa eetching, kapangyarihan, oras, atbp. 2. Kalidad ng Eetching: Ang kalidad ng eetching ng mga materyales na may mababang dimensional ay direktang nakakaapekto sa kanilang pagganap at aplikasyon, at kinakailangan kontrolin ang rate at sugat ng eetching upang maiwasan ang sobrang o kulang na eetching. 3. Pagkakaisa ng Eetching: Mahalaga ang pagkakaisa ng eetching ng mga materyales na may mababang dimensional sa paghahanda ng mataas-kalidad na mga device, at kinakailangan kontrolin ang mga parameter tulad ng temperatura, bilis ng pamumuhunan ng gas, at presyon sa proseso ng eetching upang siguruhin ang pagkakaisa ng eetching. 4. Pagproseso pagkatapos ng eetching: Pagkatapos ng eetching, kinakailangan malinis at tratuhin ang sample upang alisin ang mga produkto ng eetching at natitirang mga gas na ginagamit sa eetching, siguradong mainam at maaaring panatilihing magandang ang kalidad ng ibabaw at estabilidad ng sample.
Ang dalawang dimensyonal na elektronikong matalas na materyales ay tumutukoy sa bagong dalawang dimensyonal na materyales na may kapaligiran ng isang o maraming atomic layer na pangunahing binubuo ng pamamagitan ng covalent bonding.
Kabilang dito ang:
1. Graphene, h-BN;
2. Transition metal oxides;
3. TMCs, MX 2(M=Mo, W, Re, Ti, Zr, Hf, V, Nb, Ta, Pt, Pd, Fe; X=S, Se, Te),MoS 2,WS 2;atbp.
4. mga bahaging sulfur na basa sa III/IV/V, mga iba pa.
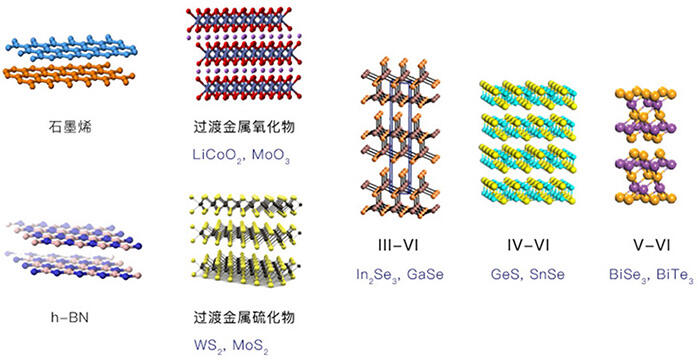
Ang maagang pag-aaral tungkol sa dalawang-dimensyonal na elektronikong mababang pelikula ng anyo, lalo na ang mga anyo ng graphene, ay pangunahing tinutukoy sa mga paraan ng paghahanda ng dalawang-dimensyonal na anyo, tulad ng mekanikal na pagpapawis, pagsasanay, depósito, atbp., pati na rin ang pag-aaral ng mga katangian ng anyo. Habang dumadagdag ang mga breakthrough sa paggawa ng malaking-anyong dalawang-dimensyonal na mababang pelikula ng anyo, nagsimulang ituring ng mga tao ang paggawa ng mga kagamitan. Ang pagiging mas mababa at pag-uugat ng dalawang-dimensyonal na mababang pelikula ng anyo ay mahalaga sa paggawa ng dalawang-dimensyonal na kagamitan. Ang tradisyonal na semikonduktor na plasmang hilig dry etching ay may dalawang fatal na kakulangan sa pagiging mas mababa at pag-uugat ng dalawang-dimensyonal na anyo:
1. Hindi sapat na rate ng pagpapawis na hindi maaaring tugunan ang presisong at matatag na pagpapawis ng 2D material na atomic layers (sub nanometer level);
2. Mataas na enerhiya na pambomba ng ion maaaring magdulot ng pinsalang estruktural sa mga 2D material, na nagreresulta sa mga defektong materyales
Ang mga karakteristikang dapat ipamamanhik ng isang espesyal na machine para sa pag-eetch ng dalaw-dalaw na materyales ay:
1. Kontrolin ang output power sa antas ng milliwatt;
2. Ang pinakamaliit na simulan ng kapangyarihan ay dapat kontrolin sa ibaba ng 5W;
3. Paggamit ng kontrol sa pag-eetch bawat layer, na may rate ng pag-eetch na maaaring ma-precisely kontrolin mula 0.3 hanggang 10 layers kada minuto
4. Ang enerhiya ng ion para sa pagbomba sa sample maaaring mababa lamang sa 10 eV o mas mababa pa
lösung für 2D-Material-Etzung - SHL 100 μ/200 μ - RIE
Nailimbag namin ang serye ng makina na SHL 100 μ/200 μ - RIE batay sa teknolohiya ng microplasma upang tugunan ang mga isyu sa aplikasyon ng pagsusulat ng disenyo sa materyales na 2D na nabanggit sa itaas. Ginagamit ang makina para sa etching ng pagbabawas ng layer at patterned etching ng mga materyales na 2D tulad ng graphene. Ipinapakita ng Figura 2 ang anyo ng makina ng etching ng materyales na 2D.

Ang pangunahing aplikasyon ng mga makina ng etching ng materyales na 2D ay:
1. Etching ng paghiwa ng materyales na 2D upang maghanda ng mga sample ng materyales na 2D na may isang layer o kaunting layer
2. Pagpaputol ng paterno ng material na 2D upang maghanda ng mga device na 2D material
3. Pagproseso ng pagbabago ng material na 2D
Pangunahing indikador ng pagganap ng machine sa etching ng material na dalawang dimensyon:
1. Maaaring handlean ang mga sample hanggang apat na pulgada/o walong pulgada at mas maliit sa sukat;
2. Ultra mahina plasma etching: Maaring makamit ang proseso ng kapangyarihan na mababa lamang sa 3 W (@ 100mm electrode) RF (@ 13.56 MHz), may kapansin-pansin na mababa lamang sa 38 mW/cm2 at isang output power na katiwalian ng mas mababa sa 0.1 W;
3. Ang enerhiya ng ion para sa pagbomba ng sample maaaring mababa bilang 10 eV;
4. Maaari nito mongahin ang maligalig at maayos na etching ng atomic layer mula sa 0.1 layer/min hanggang 1 layer/min;
Ang pangunahing konpigurasyon ng machine para sa etching ng dalawdimesyonal na material ay:
1. Maaaring ikonekta ito sa 3 hanggang 8 na proseso ng mga gas at digital na kontrolin gamit ang metal sealed MFC;
2. Gamit ang semiconductor grade 6061 aluminum bilang material ng proseso chamber upangtanggalin ang kontaminasyon ng sample sa pamamagitan ng mga elementong impurity sa mga materyales sa bulaklak na husto;
3. Ang load lock chamber ay maaaring ikonfigura, at maaabot ng background vacuum ng process chamber ang 4 x 10-4 Pa;
4. Puno ng awtomatikong kontrol ng proseso, naibahaging pamamahala sa pag-login ng gumagamit, real-time na pagsasalin ng komprehensibong datos ng proseso at datos ng estado ng makina, pamamahala at tawag sa library ng proseso ng Recipe, pamamahala sa siklo ng buhay ng komponente at pagsisiya sa sarili ng mga problema.
grapikal na resulta ng etching machine para sa 2D material:
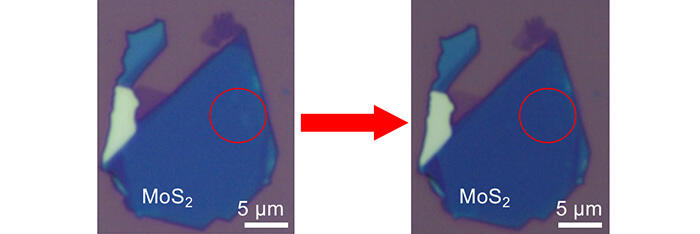
SHL100μ-RIE, 38 mW/cm 2, 10s: Ilipat ang natitirang dumi sa ibabaw ng mas kaunting layert na nai-flake MoS 2.
Mula sa koponan ni Sun Jian & Liu Xiaochi, Eskwela ng Fisika at Elektronika ng Central South University.

SHL100μ-RIE, 51 mW/cm 2, 3s: I-eetch ang MoS 2layer-by-layer.
Mula sa koponan ni Sun Jian & Liu Xiaochi, Eskwela ng Fisika at Elektronika ng Central South University.
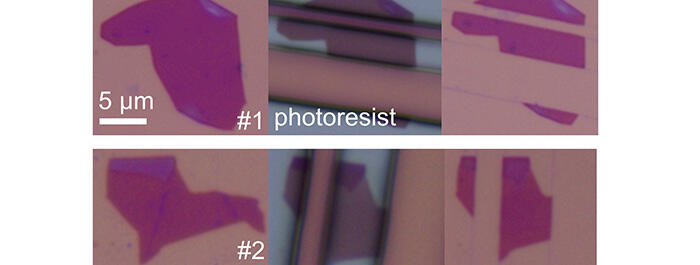
SHL100μ-RIE, 0.5 W/cm 2: Etch Graphene layer-by-layer.
Mula sa koponan ni Sun Jian & Liu Xiaochi, Eskwela ng Fisika at Elektronika ng Central South University.
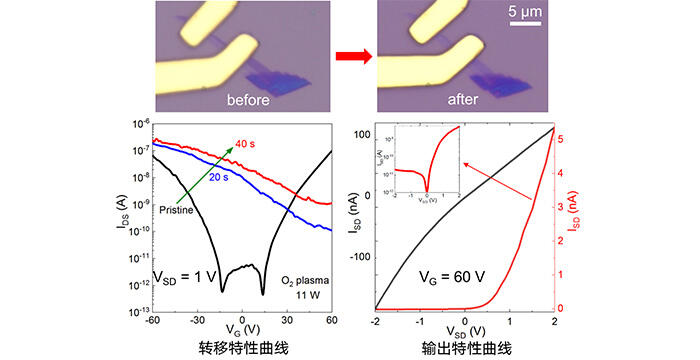
SHL100μ-RIE, 140 mW/cm 2: WSe 2p-uri ng doping.
Mula sa koponan ni Sun Jian & Liu Xiaochi, Eskwela ng Fisika at Elektronika ng Central South University.
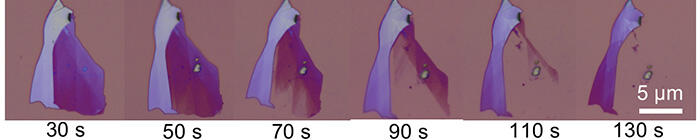
SHL100μ-RIE, 0.5 W/cm 2: Etch Graphene layer-by-layer.
Mula sa koponan ni Sun Jian & Liu Xiaochi, Eskwela ng Fisika at Elektronika ng Central South University.

SHL100μ-RIE, Etch WS 2layer-by-layer.
Mula sa Xuefei Li Team, School of Huazhong University of Science and Technology.
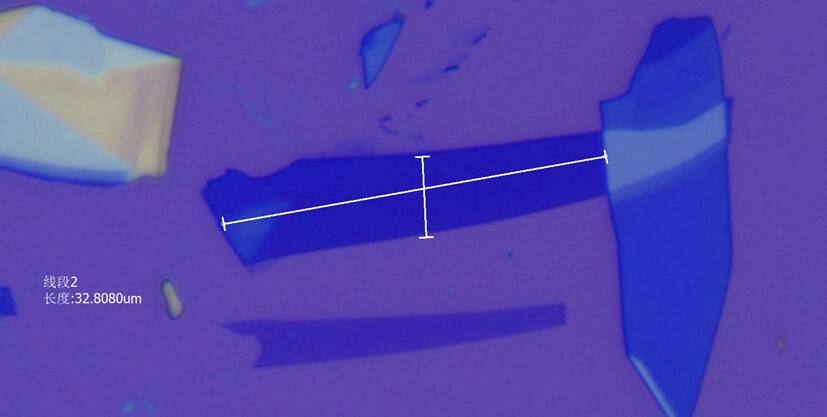
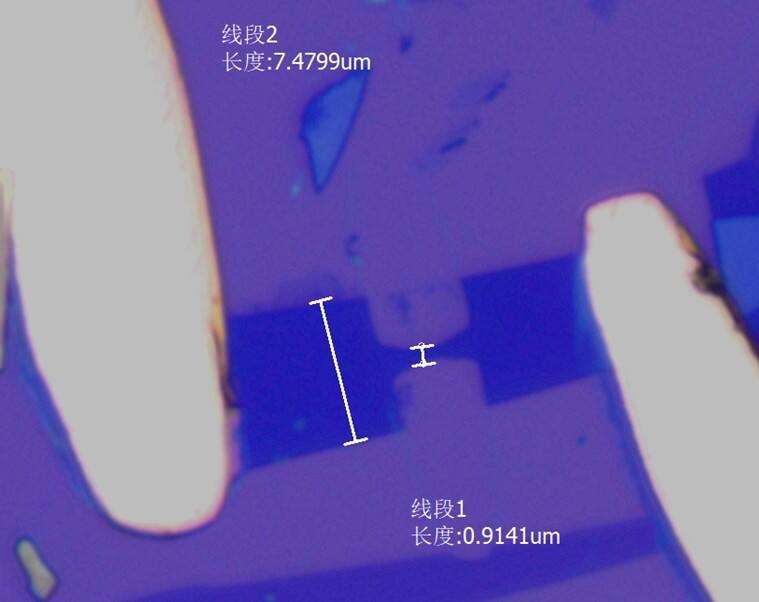
SHL100μ-RIE, Etch Graphene layer-by-layer.
Copyright © Guangzhou Minder-Hightech Co.,Ltd. Lahat ng Karapatan ay Nakalaan