
A low dimensional anyagok etchingje (alacsony dimenziós anyagok lehanyagolása) azt a folyamatot jelenti, amikor két dimenziós anyagokat (mint például a gráfén, molybdenum disszulfid stb.) és egy dimenziós anyagokat (mint például nanohajtók, nanocsövek stb.) etchelünk. Az alacsony dimenziós anyagok etchingjének célja olyan nanostruktúrák előkészítése, amelyek adott alakúak és méretűek, hogy elérjük a anyag tulajdonságainak és eszközök teljesítményének irányítását és optimalizálását. Az alacsony dimenziós anyagokat általában kémiai etching módszerekkel etcheljük. Ezt a folyamatot kémiai reakciók hasznosítják az anyagok feldolgozására, és a gyakran használt kémiai etching módszerek közé tartozik a hagyományos etching és a száraz etching.
A alacsony dimenziós anyagokat érintő nehézségek főképpen a következők: 1. Etčelési kiválasztás: Különböző alacsony dimenziós anyagoknak különböző igények vannak az etčelési feltételekkel kapcsolatban, és megfelelő etčelési feltételeket kell kiválasztani a anyag konkrét tulajdonságainak megfelelően, például etčelési gáz, teljesítmény, idő stb. 2. Etčelési minőség: Az alacsony dimenziós anyagok etčelési minősége közvetlenül befolyásolja a teljesítményüket és alkalmazásukat, és szükséges az etčelési sebesség és mélység ellenőrzése annak érdekében, hogy elkerüljük az túlzott vagy elégtelen etčelést. 3. Etčelési egyenletűség: Az alacsony dimenziós anyagok etčelési egyenletűsége döntő fontosságú magas minőségű eszközök előállításához, és szükséges a hőmérséklet, a gázfolyam és a nyomás ilyen paraméterek ellenőrzése az etčelési folyamat során az etčelési egyenletűség biztosítása érdekében. 4. Etčelés utáni kezelés: Az etčelés után a mintát tisztítani és kezelni kell az etčelési termékek és maradék etčelési gázok eltávolítása érdekében, valamint a minta felületi minőségének és stabilitásának biztosítása érdekében.
A két dimenziós elektronikus vékony filmtőzsdékek olyan új két dimenziós anyagokra utalnak, amelyeknek egy vagy néhány atom vastagságú rétege van, és főként kovalens kötelékkel alakulnak ki.
Főleg az alábbiakat tartalmazzák:
1. Gráfén, h-BN;
2. Átmeneti fémbesorítások oxiddel;
3. TMC-k, MX 2(M=Mo, W, Re, Ti, Zr, Hf, V, Nb, Ta, Pt, Pd, Fe; X=S, Se, Te), MoS 2, WS 2;stb.
4. Részleges III/IV/V súlfur-alapú anyagok stb.
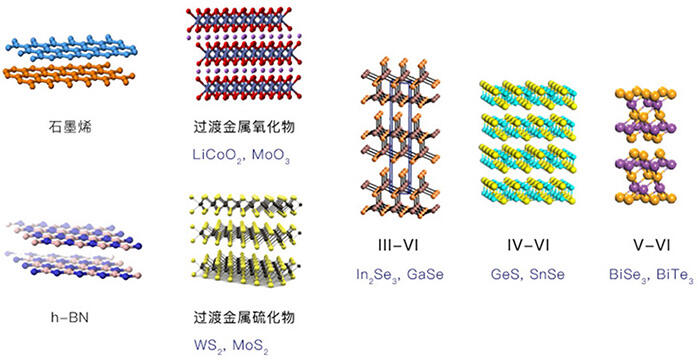
A korai kutatás a két dimenziós elektronikus vékony szalagtanyér anyagokon, különösen a gráfén anyagokon fókuszált a két dimenziós anyagok előállítási módszereire, például a mechanikai leválasztásra, a redukcióra, a sedimentációra stb., valamint az anyagi tulajdonságok tanulmányozására. A nagy méretű két dimenziós vékony szalagtanyér-anyagok előállításának folyamatos áttörései mellett a figyelem mostantól a berendezések előállítására fordul. A két dimenziós vékony szalagtanyér-anyagok vékonyítása és mintázása kulcsa a két dimenziós berendezések elkészítésének. A hagyományos halványító plazma-száraz etching módszer két lényeges hátránya van a két dimenziós anyagok vékonyítására és mintázására nézve:
1. A túl magas etching sebesség nem felel meg a pontos és stabil atomos rétegek (altérméter szint) etching-jéhez;
2. A magas energia íonbombázás strukturális károkat okozhat a 2D anyagokban, ami anyagi hibákat eredményez.
A két dimenziós anyagok szakmai etching gépjenek a következő tulajdonságokkal kell rendelkeznie:
1. A kimeneti teljesítményt milliwatt szinten kell szabályozni;
2. Az minimális indítási teljesítményt alább 5W-nél kell szabályozni;
3. Rétegenkénti etching-vezérlés, amely pontosan szabályozható 0,3 és 10 réteg per perc között.
4. Az ionenergia a minta bombázására 10 eV vagy annál alacsonyabb lehet.
2D Anyag Etching Megoldás - SHL 100 μ/200 μ - RIE
A fentiekben említett két dimenziós anyagok mintázásának alkalmazási problémáinak megoldása érdekében fejlesztettük ki az SHL 100 μ/200 μ - RIE sorozatú gépet a mikroplazma technológián alapulóan. A gép használatos két dimenziós anyagok rétegszám csökkentésére irányuló etchingre és mintázott etchingre, például a gráfén esetében. A képernyőn látható az ábrán a két dimenziós anyagok etchingére szolgáló gép kinéze.

A két dimenziós anyagok etching gépeinek fő alkalmazásai a következők:
1. Két dimenziós anyagok rétegszámcsökkentésének etchingje egyrétegű vagy kevesebb rétegbeli két dimenziós anyagminták előkészítésére.
2. 2D anyag mintavételezése eszközök készítéséhez
3. 2D anyag módosító feldolgozás
Két dimenziós anyag vékonyító gép jellemzői:
1. Kezelhetőnek olyan minták, amelyek mérete maximum négy/hét hüvelyős és kisebbek;
2. Ultrahalvány plazma vékonyítás: elérhető egy olyan feldolgozási teljesítmény, amely minimum 3 W (@ 100mm elektroda) RF (@ 13,56 MHz), a teljesítmény sűrűsége minimum 38 mW/cm2 és az kimeneti teljesítmény pontossága kevesebb, mint 0,1 W;
3. Az ionenergia a minta bombázására minimum 10 eV-ig beállítható;
4. Stabil és pontos atomi réteg etching-et érhet el 0,1 réteg/perc és 1 réteg/perc között;
A két dimenziós anyag etching gép fő konfigurációja:
1. Beállítható 3-tól 8 folyamatgázzel és fémes záró MFC-val digitálisan ellenőrizve;
2. A folyamatkamra anyaga a 6061-alumínium, amely kizárja a nem fémből származó szennyező elemek árusodását;
3. A terhelési zárt komornak testreszabható, és a folyamatkomor hátterének vakuumja elérheti 4 x 10-4 Pa-ig;
teljesen automatikus folyamatvezérlés, osztályozott felhasználói bejelentkezési kezelés, valamint a teljes folyamatadatok és gépállapot-adatok valós idejű rögzítése, recept-folyamat könyvtár kezelése és meghívása, komponens élettartam-kezelés és hibaautomatizmus.
2D anyag etched grafikai eredmények:
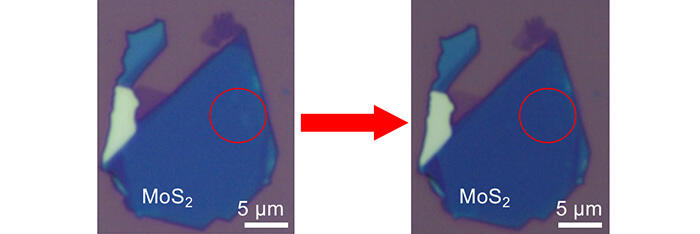
SHL100μ-RIE, 38 mW/cm 2, 10s: Több rétegű MoS-feldobások felszínén maradék tisztítása 2.
Sun Jian és Liu Xiaochi csapata, Közép-déli Egyetem Fizika és Elektronika Kar től.

SHL100μ-RIE, 51 mW/cm 2, 3s: MoS réteg etelése 2rétegérti eljárással.
Sun Jian és Liu Xiaochi csapata, Közép-déli Egyetem Fizika és Elektronika Kar től.
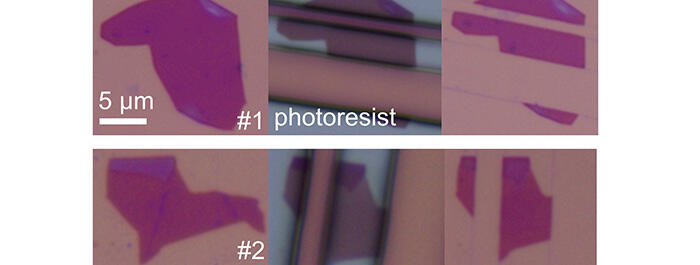
SHL100μ-RIE, 0.5 W/cm 2: Etch Graphene rétegenként.
Sun Jian és Liu Xiaochi csapata, Közép-déli Egyetem Fizika és Elektronika Kar től.
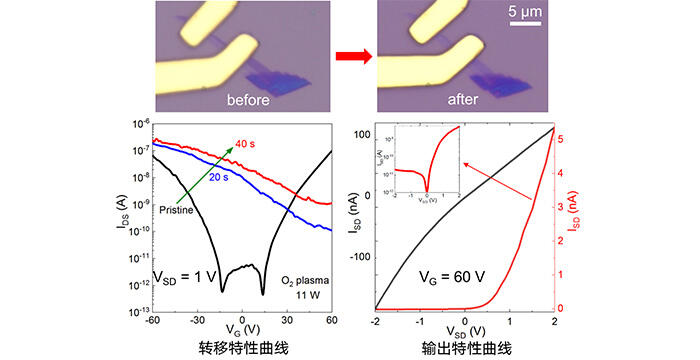
SHL100μ-RIE, 140 mW/cm 2: WSe 2p-Típusú doborzás.
Sun Jian és Liu Xiaochi csapata, Közép-déli Egyetem Fizika és Elektronika Kar től.
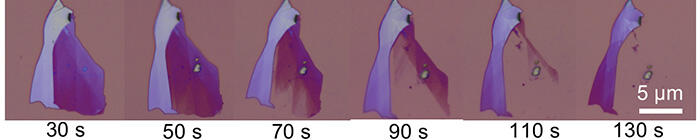
SHL100μ-RIE, 0.5 W/cm 2: Etch Graphene rétegenként.
Sun Jian és Liu Xiaochi csapata, Közép-déli Egyetem Fizika és Elektronika Kar től.

SHL100μ-RIE, Etch WS 2rétegérti eljárással.
Xuefei Li csapatból, a Huazhong University of Science and Technology Kémiailag Technológiai Iskola.
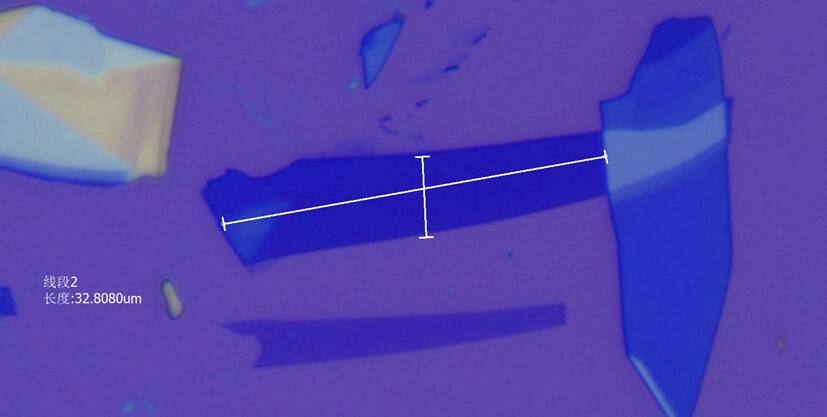
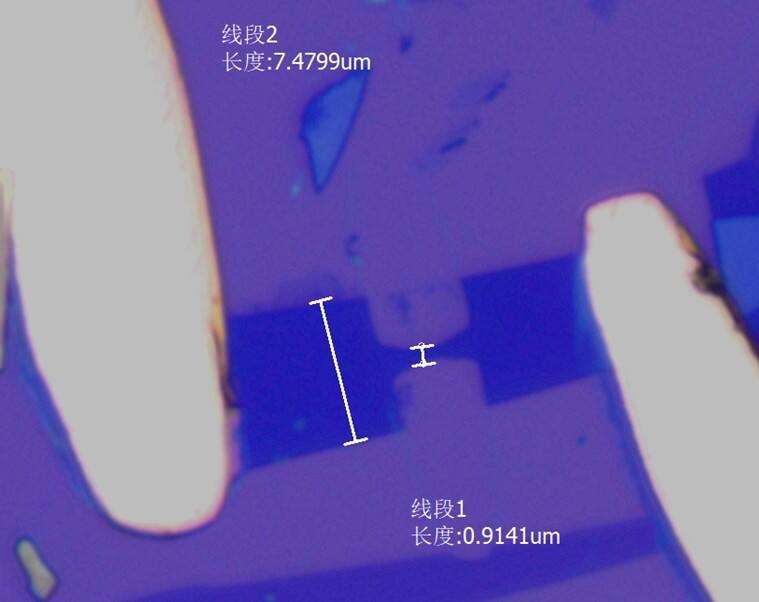
SHL100μ-RIE, Grafén rétegenkénti leértés.
Copyright © Guangzhou Minder-Hightech Co.,Ltd. All Rights Reserved