
Matala ulottuvuuden materiaalien kaivo tarkoittaa prosessia, jossa kavotaan kahdenulotteisia materiaaleja (kuten grafeeni, molibdaanidisulfidi jne.) ja yhdenulotteisia materiaaleja (kuten nanoketjuja, nanosähkönsyötteitä jne.). Matala ulottuvuuden materiaalien kaivon tarkoituksena on valmistaa nanostruktuureja tiettyjen muotojen ja kokojen mukaisesti, jotta voidaan saavuttaa materiaalien ominaisuuksien ja laitteiden suorituskyvyn hallinta ja optimointi. Matala ulottuvuuden materiaalit kavotaan yleensä kemiallisilla kaivomenetelmillä. Se käyttää kemiallisia reaktioita materiaalien käsittelyyn, ja yleisiin kemiallisille kaivomenetelmille kuuluvat kostea kaivo ja kuiva kaivo.
Vaikeuksia matalaulotteisten materiaalien puolustuksessa on pääasiassa seuraavat: 1. Puolustusvalinta: Erilaisilla matalaulotteisilla materiaaleilla on eri vaatimuksia puolustusehdoista, ja sopivat puolustusehdot täytyy valita materiaalin ominaisuuksien perusteella, kuten puolustuskasvihuone, voima, aika jne. 2. Puolustuslaatu: Matalaulotteisten materiaalien puolustuslaatu vaikuttaa suoraan niiden toimintoon ja sovelluksiin, ja on tarpeen hallita puolustusrataa ja syvyyttä välttääkseen liiallista tai epäriittävää puolustusta. 3. Puolustuksen tasaisuus: Matalaulotteisten materiaalien puolustuksen tasaisuus on ratkaiseva korkealaatuisten laitteiden valmistamiseksi, ja on tarpeen hallita parametreja, kuten lämpötila, kaasuvirtausnopeus ja paine puolustusprosessin aikana varmistaakseen puolustuksen tasaisuuden. 4. Jälkikäsittely puolustuksen jälkeen: Puolustuksen jälkeen näytteen täytyy puhdistaa ja käsitellä poistaakseen puolustustuotteet ja jäljellä olevat puolustuskaasut, varmistaakseen näytteen pinta-laadun ja vakauden.
Kaksulaitaiset elektroniset ohut elokuvamateriaalit viittaavat uusiin kaksulaitaisiin materiaaleihin, joiden paksuus on yhden tai muutaman atomikerroksen mittainen ja jotka muodostuvat pääasiassa kovalenttisista sidonnista.
Pääasiassa sisältää:
1. Grafeeni, h-BN;
2. Siirtymismetallien oksidit;
3. TMCs, MX 2(M=Mo, W, Re, Ti, Zr, Hf, V, Nb, Ta, Pt, Pd, Fe; X=S, Se, Te), MoS 2, WS 2;jne.
4. Osittainen III/IV/V hiilijärjestelmäperusteinen materiaali jne.
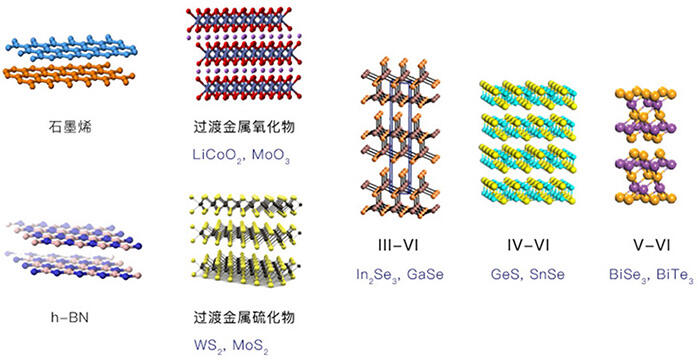
Alkuun mennessä tutkimus kahdenlaisista elektronisista ohutkakkumateriaaleista, erityisesti grafeenimateriaaleista, keskittyi pääasiassa kahdenlaisien materialien valmistusmenetelmiin, kuten mekaaniseen erottamiseen, vähentämiseen, tippaamiseen jne., sekä materiaalien ominaisuuksien tutkimiseen. Suurten kahdenlaisisten ohutkakkumateriaalien valmistuksen jatkuvien läpimurtojen myötä ihmiset ovat alkanut siirtää huomiota laitteiden valmistukseen. Kahdenlaisisten ohutkakkumateriaalien ohutustaminen ja mallintaminen ovat avainasemassa kahdenlaisisten laitteiden valmistuksessa. Perinteinen semikonduktoripasma kuiva-etsintämenetelmällä on kaksi vakavaa haittaa kahdenlaisisten materiaalien ohutustamisessa ja mallintamisessa:
1. Liian suuri etsintänopeus ei vastaa tarkkaa ja vakavaa etsintää 2D-materiaalien atomikerrosten (alaneliötaso) osalta;
2. Korkean energian ionien bombardointi voi aiheuttaa rakenteellista vahingoa 2D-materiaaleille, mikä johtaa materiaalipiikkoihin.
Kahdenlaisia materiaaleja varten suunniteltu erikoispuolustin pitäisi omata seuraavia ominaisuuksia:
1. Ohjaa tulot voimatasolla, joka on milliwattitasolla;
2. Minimikäynnistysvoima pitäisi hallita alle 5W;
3. Kerroin kerrookselta puolustusohjaus, jonka puolustusnopeus voidaan tarkasti ohjata 0,3–10 kerroksen välillä minuutissa.
4. Ionien energia ottaessa näytteen voi olla vain 10 eV tai vähemmän.
2D-Materiaali Etusratkaisu - SHL 100 μ/200 μ - RIE
Olemme kehittäneet SHL 100 μ/200 μ - RIE sarjan koneen mikroplasma-tekniikan pohjalta ratkaistaksemme mainitut kaksiulotteisten materiaalien muotoilun sovellusongelmat. Kone käytetään kahdeksulotteisten materiaalien, kuten grafeenin, kerrosten vähentämiseen ja muotoiltuun etusaamaan. Kuvassa 2 on kahdeksulotteisen materiaalien etusaamukoneen ulkonäkö.

Kahdeksulotteisten materiaalien etusaamukoneiden päätavoitteet ovat:
1. 2D-materiaalin eristys-etusaaminen valmistaaksesi yksikerroksinen tai harva kerros 2D-materiaaliprobe.
2. 2D-materiaalin kaaviomuotoilu laitteiden valmistamiseksi
3. 2D-materiaalin muokkausprosessointi
Kaksiulotteisen materiaalin etkäyksen laitteen ytimen suorituskykyindikaattorit:
1. Käsittelee otoksia, joiden koko on enintään neljä tuumaa / kahdeksan tuumaa ja pienempi;
2. Ultrapohja plasma-etching: Se pystyy saavuttamaan prosessitehoon vain 3 W (@ 100mm elektrodi) RF (@ 13,56 MHz), jonka teho tiheyden minimi on 38 mW/cm2 ja tulosteon tarkkuus alle 0,1 W;
3. Ionien energia otteelle voi olla alhaisin 10 eV;
4. Se voi saavuttaa vakion ja tarkkaan atomitasoisen puolustuksen 0,1 kerrosta/minuutista 1 kerroksen/minuuttiin;
Kahdenlaisen materiaalin puolustuslaite pääasentelmä on:
1. Sen voi varustaa 3:lle - 8:lle prosessikaasulle ja digitaalisesti hallita metallisella MFC:n sulkeumalla;
2. Käyttämällä semikonduktoritasoa 6061 aluminiumia prosessikameroon materiaalina poistaakseen näytteen saastuminen rautalangitseerestä impurisuhteista;
3. Latauslukkojärjestelmä voidaan konfiguroida, ja prosessikameroon saavutetaan taustavakuumi 4 x 10-4 Pa;
täysin automaattinen prosessinohjaus, kerroin käyttäjätunnistuksen hallinta, reaaliaikainen prosessidatan ja koneen tiladatan tallentaminen, Reseptiprosessikirjaston hallinta ja kutsu, komponenttien elinkaarenhallinta sekä vian itsehakeminen.
2D-materiaalien kuoppauskone graafiset tulokset:
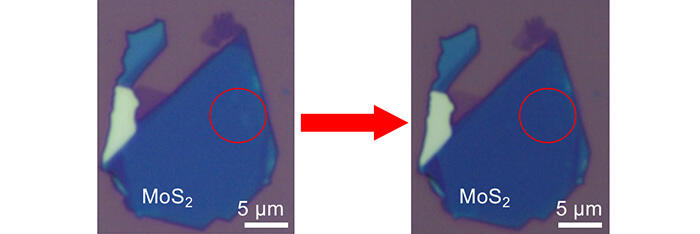
SHL100μ-RIE, 38 mW/cm 2, 10s: Monikerroksisten pinnan jälkelöiden puhdistus harvemmalla kerroksella flaked MoS 2.
Sun Jian & Liu Xiaochi -tiimiltä, Keski-idän yliopiston fysiikan ja elektronikan koulusta.

SHL100μ-RIE, 51 mW/cm 2, 3s: Kera MoS 2kerroin-kerroin.
Sun Jian & Liu Xiaochi -tiimiltä, Keski-idän yliopiston fysiikan ja elektronikan koulusta.
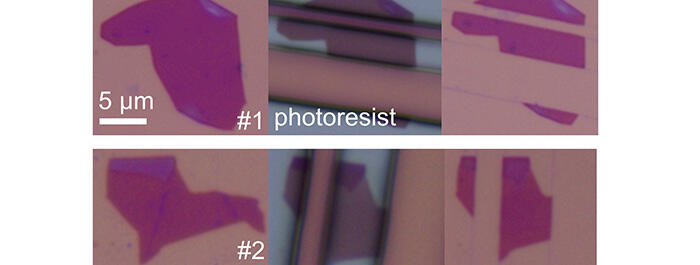
SHL100μ-RIE, 0.5 W/cm 2: Kerroksen grafeeni tasapuoleisesti kerroin-kerrokselta toiselle.
Sun Jian & Liu Xiaochi -tiimiltä, Keski-idän yliopiston fysiikan ja elektronikan koulusta.
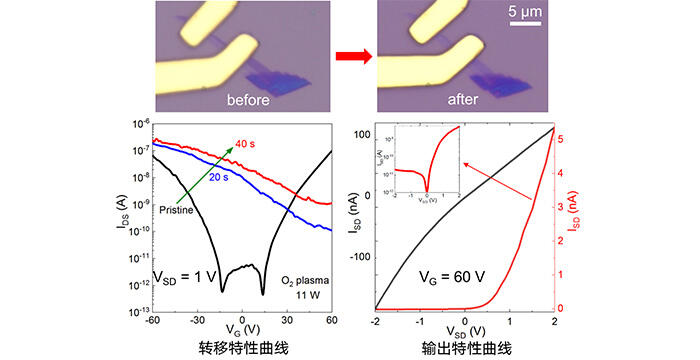
SHL100μ-RIE, 140 mW/cm 2: WSe 2p-tyyppinen doping.
Sun Jian & Liu Xiaochi -tiimiltä, Keski-idän yliopiston fysiikan ja elektronikan koulusta.
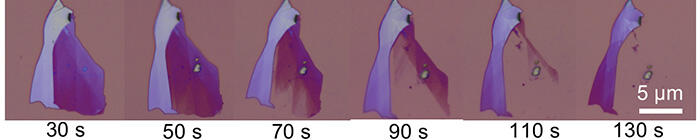
SHL100μ-RIE, 0.5 W/cm 2: Kerroksen grafeeni tasapuoleisesti kerroin-kerrokselta toiselle.
Sun Jian & Liu Xiaochi -tiimiltä, Keski-idän yliopiston fysiikan ja elektronikan koulusta.

SHL100μ-RIE, Kerää WS 2kerroin-kerroin.
Xuefei Li -tiimiltä, Huazhong University of Science and Technology -yliopiston korkeakoulusta.
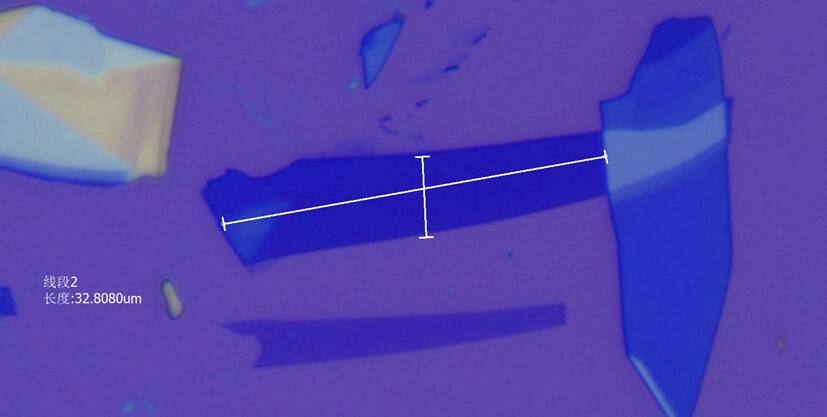
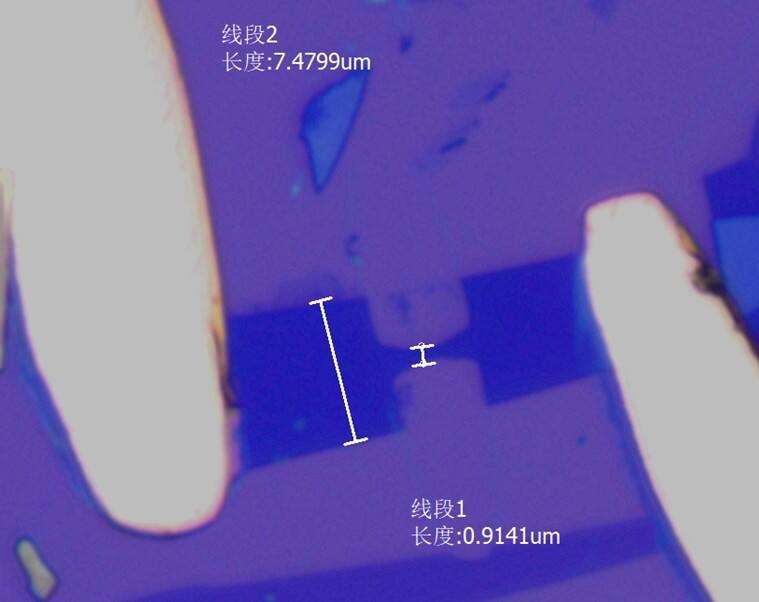
SHL100μ-RIE, kaadaa graafeenia kerroksittain.
Copyright © Guangzhou Minder-Hightech Co.,Ltd. Kaikki oikeudet pidätetään