
Ettering av lavdimensjonale materialer refererer til prosessen med å ettre to-dimensjonale materialer (som graphene, molibden disulfid osv.) og en-dimensjonale materialer (som nanotråder, nanorør osv.). Målet med ettering av lavdimensjonale materialer er å forberede nanostrukturer med spesifikke former og størrelser for å oppnå kontroll og optimalisering av materialeegenskaper og enhetsprestasjoner. Lavdimensjonale materialer ettes vanligvis ved å bruke kjemisk etteringsmetoder. Den bruker kjemiske reaksjoner for å behandle materialene, og vanlige kjemiske etteringsmetoder omfatter vannettering og tørrettering.
Vanskelighetene ved å grave lavdimensjonale materialer omfatter hovedsakelig: 1. Gravvalg: Forskjellige lavdimensjonale materialer har ulike krav til gravbetingelser, og det er nødvendig å velge egne gravbetingelser basert på materialets spesifikke egenskaper, som f.eks. gravgass, kraft, tid osv. 2. Gravkvalitet: Gravkvaliteten av lavdimensjonale materialer påvirker direkte deres ytelse og anvendelser, og det er nødvendig å kontrollere gravhastigheten og dybden for å unngå overdreven eller utilstrekkelig gravning. 3. Gravens jevnhet: Gravens jevnhet av lavdimensjonale materialer er avgjørende for å lage høykvalitets enheter, og det er nødvendig å kontrollere parametere som temperatur, gassstrøm og trykk under gravprosessen for å sikre gravens jevnhet. 4. Ettergravbehandling: Etter gravning må prøven renses og behandles for å fjerne gravprodukter og resterende gravgasser, for å sikre overflatekvaliteten og stabilheten til prøven.
To-dimensjonale elektroniske tynefilmmaterialer refererer til nye to-dimensjonale materialer med enkelt eller noen atomlag tykkelse, hovedsakelig dannet av kovalente bindinger.
Hovedsaklig inkluderer:
1. Graphen, h-BN;
2. Overgangsmetalloksidere;
3. TMC'er, MX 2(M=Mo, W, Re, Ti, Zr, Hf, V, Nb, Ta, Pt, Pd, Fe; X=S, Se, Te), MoS 2, WS 2;etc.
4. Delvis III/IV/V svovelbaserte materialer, osv.
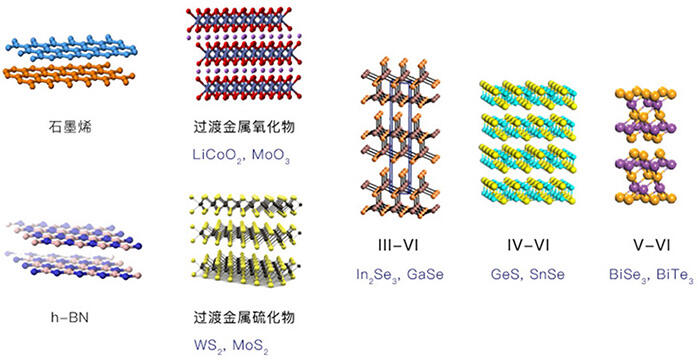
Tidlig forskning på to-dimensjonale elektroniske tyne filmmaterialer, spesielt grafenmaterialer, fokuserte hovedsakelig på fremgangsmåter for å lage to-dimensjonale materialer, som mekanisk avskiling, reduksjon, avsetting, osv., samt studiet av materialeegenskaper. Med de kontinuerlige gjennombruddene i fremstillingen av store to-dimensjonale tynnfilmmaterialer, har folk begynt å rette oppmerksomheten mot fremstillingen av enheter. Tyngking og mønstering av to-dimensjonale tynnfilmmaterialer er avgjørende for fremstillingen av to-dimensjonale enheter. Den tradisjonelle halvlederplasmadryst etch-metoden har to fatale ulemper ved tyngking og mønstering av to-dimensjonale materialer:
1. For høy ettingshastighet kan ikke oppfylle nøye og stabile etting av 2D materialeatomlag (under nanometer nivå);
2. Høyenergi jonbombardering kan forårsake strukturell skade på 2D-materialer, noe som fører til materialefeil
Karakteristikene en spesialisert etchingsmaskin for to-dimensjonale materialer bør ha er:
1. Kontroller utgangs effekten på milliwatt-nivå;
2. Den minste starteffekten bør kontrolleres under 5W;
3. Lag for lag etching-kontroll, med en etchingsrate som kan nøyaktig kontrolleres mellom 0,3 og 10 lag per minutt
4. Ionenergien for å bombarden sampelen kan være så lav som 10 eV eller mindre
løsning for 2D-materialeetching - SHL 100 μ/200 μ - RIE
Vi har utviklet maskinen i SHL 100 μ/200 μ - RIE-serien basert på mikroplasmateknologi for å løse de nevnte anvendelsesutfordringene ved mønsterforming av to-dimensjonale materialer. Maskinen brukes til lagforskingsetching og mønsteretcing av to-dimensjonale materialer som graphene. Figur 2 viser utseendet på maskinen for etching av to-dimensjonale materialer.

De viktigste anvendelsene av maskiner for etching av to-dimensjonale materialer er:
1. Etching av delaminering av 2D-materialer for å forberede enkeltslags- eller fåslags-2D-materialsampel
2. Ettering av 2D materiale mønster for å forberede 2D materiale-enheter
3. Behandlingsprosess for modifisering av 2D materialer
Kjerneytelighetsindikatorer for etteringsmaskin for to-dimensjonale materialer:
1. Kan behandle prøver opp til fire tommer/åtte tommer og mindre i størrelse;
2. Ultra svakt plasmaettering: Den kan oppnå en prosesskraft så lav som 3 W (@ 100mm elektrode) RF (@ 13,56 MHz), med en krafttetthet så lav som 38 mW/cm2 og en utgangskraftsnøyaktighet på mindre enn 0,1 W;
3. Ionenergien for å bombarden sampelen kan være så lav som 10 eV;
4. Det kan oppnå stabil og nøyaktig etching av atomlag fra 0,1 lag/min til 1 lag/min;
Hovedkonfigurasjonen av maskinen for etching av to-dimensjonale materialer er:
1. Den kan være utstyrt med 3 til 8 prosessgasser og digitalt kontrollert med metallforseglet MFC;
2. Ved bruk av semiconductorgrad 6061 aluminium som materiale for prosesskammeret for å eliminere forurening av sampelen av fruktsomme elementer i rostfritt stål;
3. Lastelokkekammeren kan konfigureres, og bakgrunnsvakuumet i prosesskammeren kan oppnå 4 x 10-4 Pa;
fullstendig automatisk prosesskontroll, nivåbasert brukerinnlogging, sanntidsregistrering av fullstendige prosessdata og maskinstatusdata, Oppskriftsprosessbibliotekets administrasjon og kall, komponentlifesyklusadministrasjon og feilsjekking.
grafiske resultater fra etchingsmaskinen for 2D-materialer:
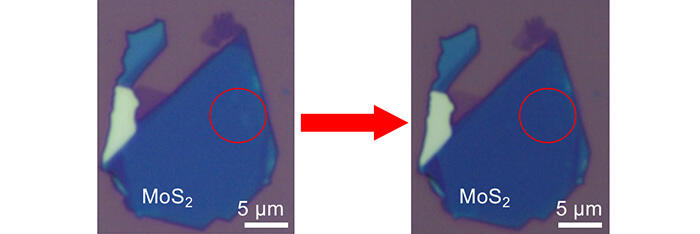
SHL100μ-RIE, 38 mW/cm 2, 10s: Ren rest på overflaten av færre lag flakket MoS 2.
Fra Sun Jian & Liu Xiaochi Team, Fysikk- og Elektronikkfakultet ved Central South University.

SHL100μ-RIE, 51 mW/cm 2, 3s: Etch MoS 2lag for lag.
Fra Sun Jian & Liu Xiaochi Team, Fysikk- og Elektronikkfakultet ved Central South University.
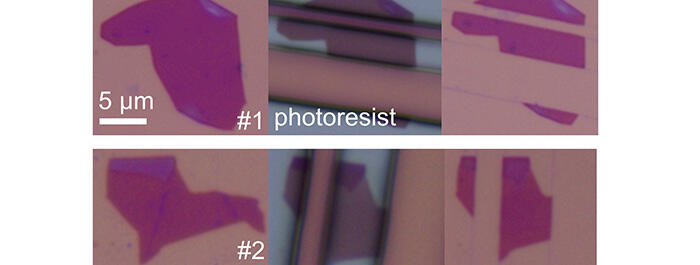
SHL100μ-RIE, 0.5 W/cm 2: Etch Graphene lag-for-lag.
Fra Sun Jian & Liu Xiaochi Team, Fysikk- og Elektronikkfakultet ved Central South University.
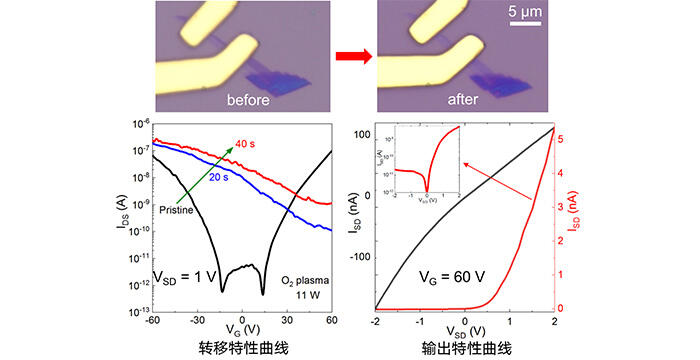
SHL100μ-RIE, 140 mW/cm 2: WSe 2p-Type doping.
Fra Sun Jian & Liu Xiaochi Team, Fysikk- og Elektronikkfakultet ved Central South University.
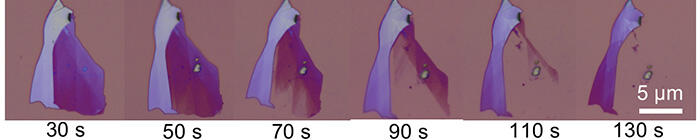
SHL100μ-RIE, 0.5 W/cm 2: Etch Graphene lag-for-lag.
Fra Sun Jian & Liu Xiaochi Team, Fysikk- og Elektronikkfakultet ved Central South University.

SHL100μ-RIE, Etch WS 2lag for lag.
Fra Xuefei Li Team, School of Huazhong University of Science and Technology.
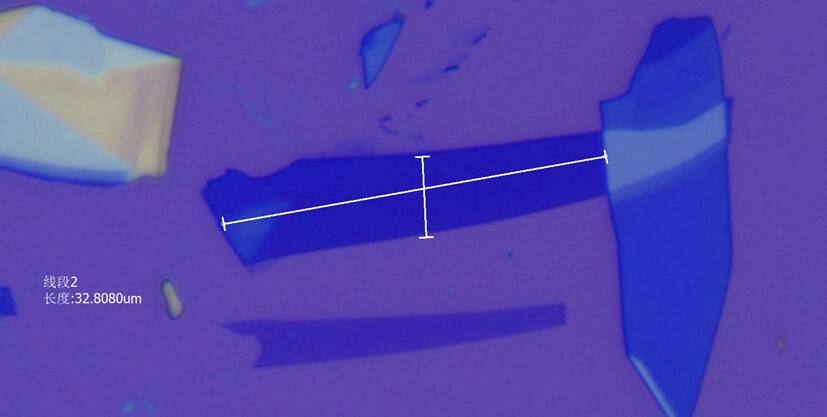
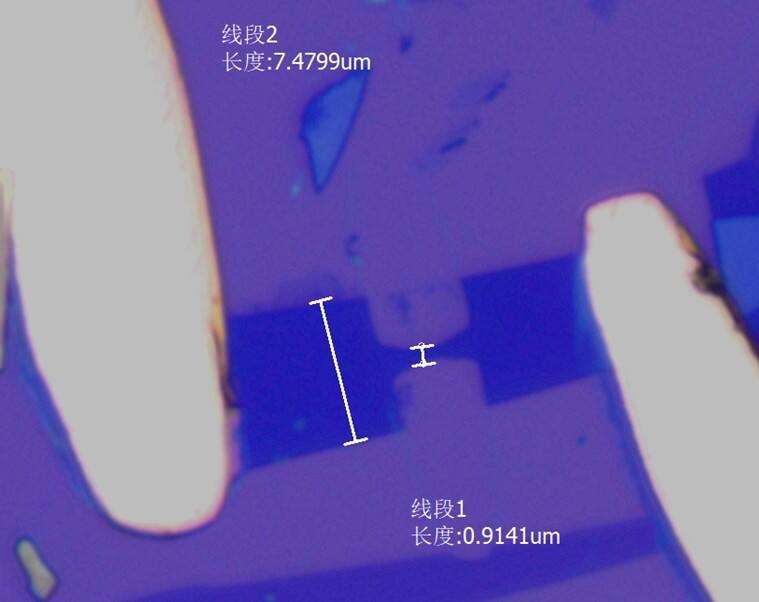
SHL100μ-RIE, Etch Graphene lag for lag.
Opphavsrett © Guangzhou Minder-Hightech Co.,Ltd. Alle rettigheter forbeholdt