
Ерозирането на нискоразмерни материали се отнася до процеса на ерозиране на двумерни материали (например графен, дисулфид молибден и т.н.) и единодименсионни материали (например нанопръти, нанотубуси и т.н.). Целта на ерозирането на нискоразмерни материали е да се подготвят наноструктури с определени форми и размери, за да се постигне контрол и оптимизация на свойствата на материалите и производителността на устройствата. Нискоразмерните материали обикновено се ерозират чрез химически методи за ерозиране. Той използва химически реакции за обработване на материалите, а най-често използваните химически методи за ерозиране включват мокро ерозиране и сухо ерозиране.
Трудностите при етчинга на нискоразмерни материали главно включват: 1. Етчингов избор: Различните нискоразмерни материали имат различни изисквания към условията за етчинг и трябва да се изберат подходящи условия за етчинг, като се основава на специфичните свойства на материалите, например етчинг гас, мощност, време и т.н. 2. Качество на етчинга: Качеството на етчинга на нискоразмерните материали直接影响 техния перформанс и приложения и е необходимо да се контролира скоростта и дълбината на етчинга, за да се избегне прекалено или недостатъчен етчинг. 3. Еднородност на етчинга: Еднородността на етчинга на нискоразмерните материали е от съществено значение за подготовкготоенето на висококачествени устройства и е необходимо да се контролират параметрите като температура, скорост на гасов поток и налягане по време на процеса на етчинг, за да се осигури еднородност на етчинга. 4. Обработка след етчинга: След етчинга пробата трябва да бъде промита и обработена, за да се премахнат продуктите от етчинга и остатъчните етчинг гасове, като се гарантира качеството и стабилността на повърхнината на пробата.
Двумерните електронни тънки пленки се отнасят до нови двумерни материали с толщина от един или няколко атома, основно формирани чрез ковалентно връзване.
Основно включва:
1. Графен, h-BN;
2. Оксиди на преходни метали;
3. TMCs, MX 2(M=Mo, W, Re, Ti, Zr, Hf, V, Nb, Ta, Pt, Pd, Fe; X=S, Se, Te), MoS 2, WS 2;и др.
4. Частично сульфидни материали на група III/IV/V и др.
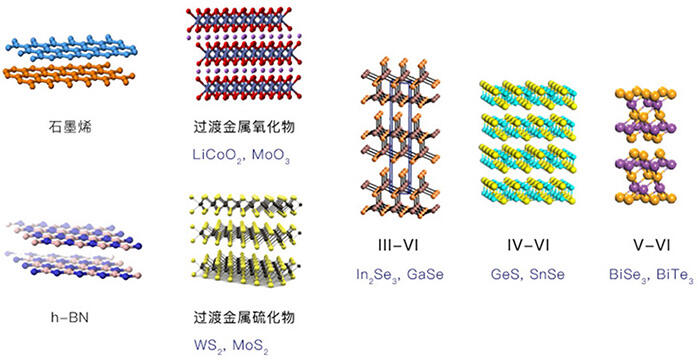
Ранните изследвания върху двумерни електронни тонки пленки, особено графеновите материали, се фокусираха предимно върху методите за приготвяне на двумерни материали, като механичното отделяне, редукцията, депозирането и др., както и върху изучаването на свойствата на материалите. С постепенните прориви в приготвянето на големи двумерни тонки пленки, хората започнаха да обърнат внимание към приготвянето на устройства. Тонуването и формирането на двумерни тонки пленки са ключови за приготвянето на двумерни устройства. Традиционният метод на семикондукторното плазмено сухо етчиване има две фатални недостатъка при тонуването и формирането на двумерни материали:
1. Прекалено висока скорост на етчиване не може да отговаря на необходимостта за точно и стабилно етчиване на атомните слоеве на 2D материала (на ниво под нанометър);
2. Високотоеннионнобомбардираниетоможедаизвикатструктурнишкодивърхдвумерниматериали,коитопродуциратдефективиматериалите
Характеристиките,коитотознаелетчещапромишленамашиназадвумерниматериалидаобладава,са:
1. Да се контролира изходната мощност на нивото на миливатове;
2. Минималната стартираща мощност трябва да бъде контролирана под 5W;
3. Контрол на етчежа слой по слой, при което скоростта на етчеж може да бъде прецизно регулирана между 0,3 и 10 слоя за минута
4. Енергията на ионите за бомбардировка на пробата може да е толкова ниска, колкото 10 еВ или по-малко
решение за етчинг на двумерни материали - SHL 100 μ/200 μ - RIE
Разработахме машината SHL 100 μ/200 μ - RIE, базирана на микроплазмена технология, за да решим проблемите с приложението на патроните на двумерни материали, споменати по-горе. Машината се използва за етчинг на намаляване на слой и патронен етчинг на двумерни материали като графен. На фигура 2 е показан външният вид на машината за етчинг на двумерни материали.

Основните приложения на машините за етчинг на двумерни материали са:
1. Етчинг на отделяне на двумерни материали за подготовкготвяне на пробы от един слой или малко слоеви двумерни материали
2. Етчинг на 2D материални образци за подготовкготвка на устройствата с 2D материали
3. Обработка на модифицираните 2D материали
Основни показатели за производителността на машината за етчинг на двумерни материали:
1. Може да обработва проби с размер до четири инча/осем инча и по-малки;
2. Супер слаб плазмен етчинг: Достига процесна мощност от само 3 В (@ 100mm електрод) РФ (@ 13,56 MHz), с мощностна густина от само 38 мВ/см2 и изходна точност на мощността под 0,1 В;
3. Енергията на ионите за бомбардировка на пробата може да е като 10 еВ;
4. Може да постигне стабилно и прецизно етчинг на атомни слоеве от 0,1 слой/мин до 1 слой/мин;
Основната конфигурация на машината за етчинг на двумерни материали е:
1. Може да се оснащи с 3 до 8 процесни газа и да се контролира цифрово с метално затворено MFC;
2. Използване на семикондукторен град 6061 алуминий като материал за процесната камера, за да се eliminира замърсяването на пробата от примесни елементи в нержавеящите материали;
3. Камерата за зареждане може да бъде конфигурирана, а вакуумът в процесната камера може да достигне 4 x 10-4 Па;
пълно автоматично управление на процеса, иерархично управление на потребителското входене, реално време за записване на обобщени процесни данни и данни за състоянието на машината, управление и извикване на библиотеката на процесите Recipe, управление на жизнения цикъл на компонентите и самодиагностика при проблеми.
графични резултати от машина за етиране на 2D материали:
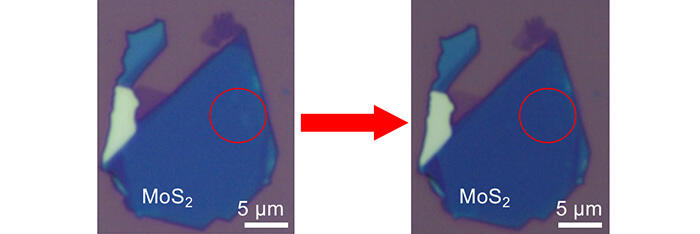
SHL100μ-RIE, 38 мВ/см 2, 10с: Изчистване на остатъците върху повърхността на по-малко слойки откъснат MoS 2.
От екипа на Сун Цянь и Лиу Сяочи, Факултет по физика и електроника на Южен централен университет.

SHL100μ-RIE, 51 мВт/см 2, 3с: Ерозия на МоS 2слой по слой.
От екипа на Сун Цянь и Лиу Сяочи, Факултет по физика и електроника на Южен централен университет.
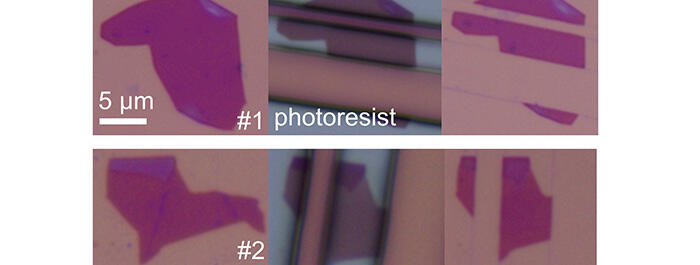
SHL100μ-RIE, 0.5 Вт/см 2: Етч на слой от графен.
От екипа на Сун Цянь и Лиу Сяочи, Факултет по физика и електроника на Южен централен университет.
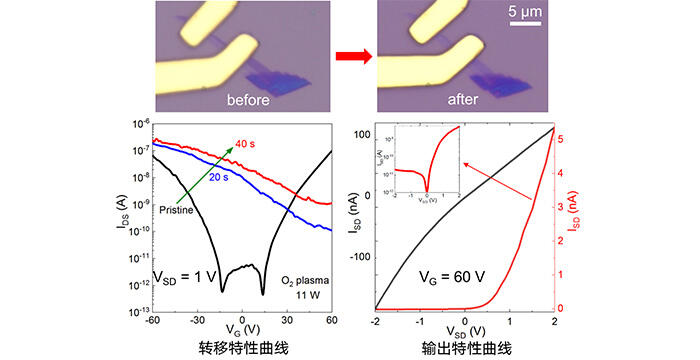
SHL100μ-RIE, 140 мВт/см 2: WSe 2p-тип допинг.
От екипа на Сун Цянь и Лиу Сяочи, Факултет по физика и електроника на Южен централен университет.
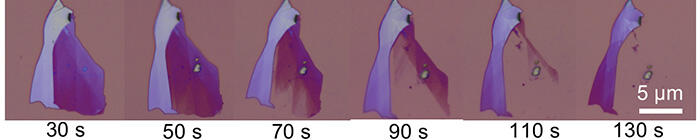
SHL100μ-RIE, 0.5 Вт/см 2: Етч на слой от графен.
От екипа на Сун Цянь и Лиу Сяочи, Факултет по физика и електроника на Южен централен университет.

SHL100μ-RIE, Етч WS 2слой по слой.
От екипа на Сюэфей Ли, Факултет по техника и наука, Университет Хуазхong.
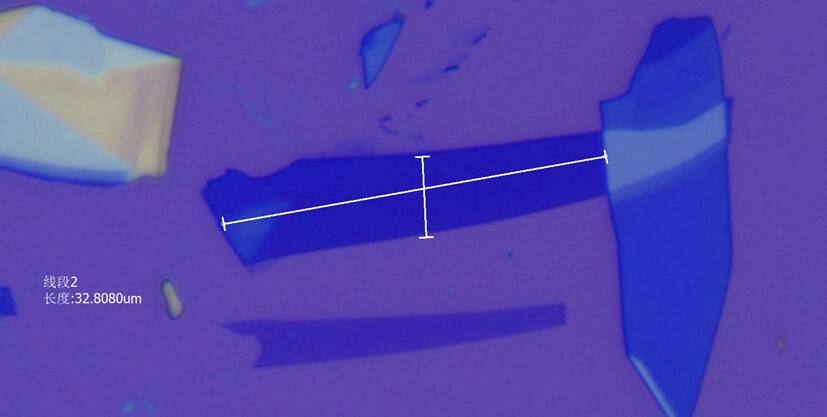
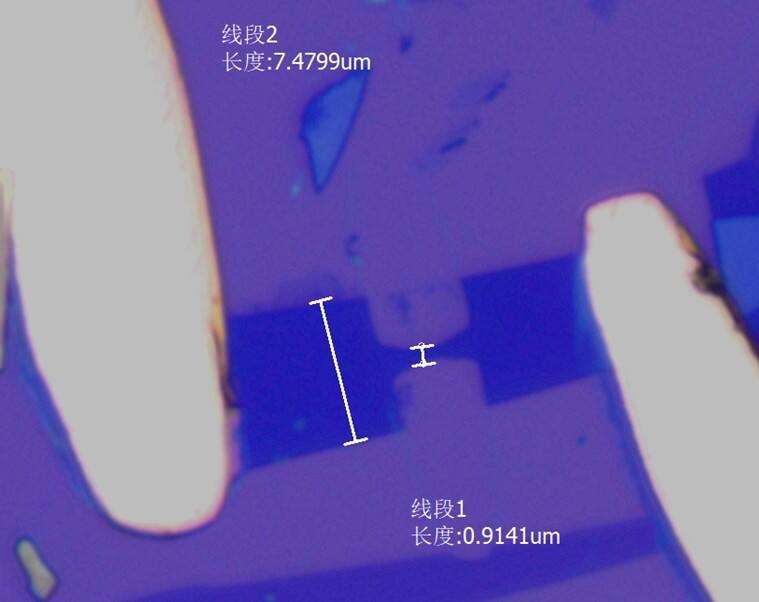
SHL100μ-RIE, Ерозиране на слой от графен по едници.
Copyright © Guangzhou Minder-Hightech Co.,Ltd. All Rights Reserved