
La technologie d'etching réactif ionique à couplage inductif est un type de RIE. Cette technologie permet de découpler la densité des ions plasmas et l'énergie ionique en contrôlant indépendamment le flux ionique, ce qui améliore ainsi la précision et la flexibilité du processus d'etching.
Les produits de la série à gravure ionique réactive couplée inductivement (ICP-RIE) à haute densité sont basés sur la technologie de plasma couplé inductivement et visent à répondre aux besoins de gravure fine et de gravure des semi-conducteurs composés. Ils offrent une excellente stabilité du procédé et une bonne répétabilité, et conviennent aux applications dans les semi-conducteurs en silicium, l'optoélectronique, les télécommunications, les composants de puissance et les dispositifs micro-ondes.



Matériaux applicables :
1. Matériaux à base de silicium : silicium (Si), dioxyde de silicium (SiO2), nitrure de silicium (SiNx), carbure de silicium (SiC)...
2. Matériaux III-V : phosphure d'indium (InP), arséniure de gallium (GaAs), nitrure de gallium (GaN)...
3. Matériaux II-VI : tellurure de cadmium (CdTe)...
4. Matériaux magnétiques/matériaux alliés
5. Matériaux métalliques : aluminium (Al), or (Au), tungstène (W), titane (Ti), tantale (Ta)...
6. Matériaux organiques : résine photosensible (PR), polymère organique (PMMA/HDMS), film mince organique...
7. Matériaux ferroélectriques/photoélectriques : niobate de lithium (LiNbO3)...
8. Matériaux diélectriques : saphir (Al2O3), quartz...
Applications associées :
1. Gravure par réseau : utilisée pour l'affichage 3D, les dispositifs micro-optiques, l'optoélectronique, etc. ;
2. Gravure des semi-conducteurs composés : utilisée pour les LED, les lasers, les communications optiques, etc. ;
3. Substrat de saphir structuré (PSS) ;
4. Gravure du niobate de lithium (LiNO3) : détecteurs, optoélectronique ;


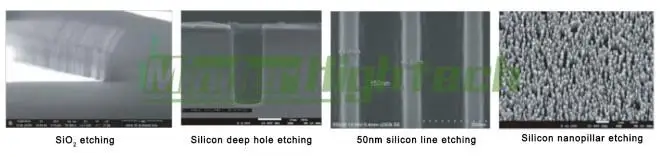
Article |
MD150S-ICP |
MD200S-ICP |
MD150CS-ICP |
MD200CS-ICP |
MD300C-ICP |
||||
Taille du produit |
≤6 pouces |
≤8 pouces |
≤6 pouces |
≤8 pouces |
Sur mesure ≥12pouces |
||||
Source de puissance SRF |
0~1000W/2000W/3000W/5000W Ajustable, appariement automatique\, 13,56MHz/27MHz |
||||||||
Source de puissance BRF |
0~300W/0~500W/0~1000W Ajustable, appariement automatique, 2MHz/13,56MHz |
||||||||
Pompe moléculaire |
Non corrosif : 600/1300 (L/s) /Sur mesure |
Anti-corrosion : 600/1300 (L/s) /Sur mesure |
600/1300(L/s) /Sur mesure |
||||||
Pompe Foreline |
Pompe mécanique \ pompe sèche |
Pompe sèche anti-corrosion |
Pompe mécanique \ pompe sèche |
||||||
Pompe de pré-vidange |
Pompe mécanique \ pompe sèche |
Pompe mécanique \ pompe sèche |
|||||||
Pression de processus |
Pression non contrôlée\0-0,1\1\10 Torr pression contrôlée |
||||||||
Type de gaz |
H2\CH4\O2\N2\Ar\SF6\CF4\ CHF3\C4F8\NF3\NH3\C2F6\Sur mesure (Jusqu'à 12 canaux, sans gaz corrosif et toxique) |
H2\CH4\O2\N2\Ar\SF6\CF4\CHF3\ C4F8\NF3\NH3\C2F6\Cl2\BCl3\HBr\ Sur mesure (Jusqu'à 12 canaux) |
|||||||
Gamme de gaz |
0~5sccm\50sccm\100sccm\200sccm\300sccm\500sccm\1000sccm\Sur mesure |
||||||||
ChargeVerrou |
Oui/Non |
Oui |
|||||||
Contrôle de la température de l'échantillon |
10°C~TempPièce / -30°C~150°C / Sur mesure |
-30°C~200°C / Sur mesure |
|||||||
Refroidissement à l'hélium arrière |
Oui/Non |
Oui |
|||||||
Doublure de cavité de processus |
Oui/Non |
Oui |
|||||||
Contrôle de la température des parois de la cavité |
Non/TempPièce-60/120°C |
TempPièce~60/120°C |
|||||||
Système de contrôle |
Automatique/Personnalisé |
||||||||
Matériau d'usinage |
Silicium-base : Si/SiO2/ SiNx/ SiC..... Matériaux organiques : PR/Organique film...... |
Silicium-base : Si/SiO2/SiNx/SiC III-V : InP/GaAs/GaN...... IV-IV : SiC II-VI : CdTe...... Matériau magnétique / matériau alliages Matériaux métalliques : Ni/Cr/Al/Cu/Au... Matériaux organiques : PR/Film organique...... Étamage profond du silicium |
|||||||



Droits d'auteur © Guangzhou Minder-Hightech Co.,Ltd. Tous droits réservés