
Технологія реактивного іонного травлення з індуктивним зв’язком є різновидом RIE. Ця технологія досягає розщеплення густини іонів плазми та енергії іонів шляхом незалежного контролю потоку іонів, тим самим покращуючи точність керування та гнучкість процесу травлення.
Серія продуктів з високощільної індуктивно зв’язаної реактивної йонної етчингової технології (ICP-RIE) базується на технології індуктивно зв’язаної плазми та призначена для точного етчингу та потреб етчингу напівпровідникових сполук. Вона має чудливу стабільність процесу та повторюваність процесу, підходить для застосування у кремнієвих напівпровідниках, оптоелектроніці, інформаційних та комунікаційних технологіях, потужних пристроях та мікрохвильових пристроях.



Призначені матеріали:
1. Матеріали на основі кремнію: кремній (Si), діоксид кремнію (SiO2), нітрид кремнію (SiNx), карбід кремнію (SiC)...
2. Матеріали типу III-V: фосфід індію (InP), арсенід галію (GaAs), нітрид галію (GaN)...
3. Матеріали типу II-VI: телурид кадмію (CdTe)...
4. Магнітні матеріали/сплави
5. Металеві матеріали: алюміній (Al), золото (Au), вольфрам (W), титан (Ti), тантал (Ta)...
6. Органічні матеріали: фоторезист (PR), органічний полімер (PMMA/HDMS), органічна тонка плівка...
7. Фероелектричні/фотоелектричні матеріали: метаниобат літію (LiNbO3)...
8. Діелектричні матеріали: сапфір (Al2O3), кварц...
Зв’язані застосування:
1. Травлення ґратки: використовується для 3D-дисплеїв, мікрооптичних пристроїв, оптоелектроніки тощо;
2. Травлення складених напівпровідників: використовується для LED, лазерів, оптичного зв’язку тощо;
3. Паттернізовані сапфірові підкладки (PSS);
4. Травлення мета-ниобату літію (LiNO3): детектори, оптоелектроніка;


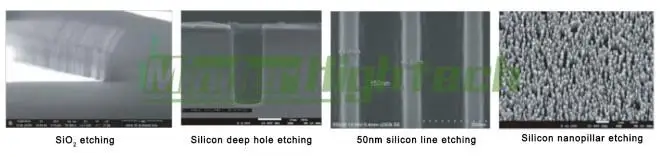
Предметом |
MD150S-ICP |
MD200S-ICP |
MD150CS-ICP |
MD200CS-ICP |
MD300C-ICP |
||||
Розмір продукту |
≤6 дюймів |
≤8 дюймів |
≤6 дюймів |
≤8 дюймів |
Нестандартний≥12дюймів |
||||
Джерело живлення SRF |
0~1000Вт/2000Вт/3000Вт/5000Вт Змінний,автоматичне відповідність\,13.56МГц/27МГц |
||||||||
Джерело живлення BRF |
0~300Вт/0~500Вт/0~1000Вт Змінний, автоматичне відповідність,2МГц/13.56МГц |
||||||||
Молекулярний насос |
Не корозійний : 600/1300 (Л/с) /Нестандартний |
Протикорозійний:600/1300 (Л/с)/Нестандартний |
600/1300(Л/с) /Нестандартний |
||||||
Помпа Foreline |
Механічний насос\/сухий насос |
Протикорозійний сухий насос |
Механічний насос\/сухий насос |
||||||
Попередній насос |
Механічний насос\/сухий насос |
Механічний насос\/сухий насос |
|||||||
Процесний тиск |
Неконтрольований тиск\/0-0.1\/1\/10Torr контролюваний тиск |
||||||||
Тип газу |
H2\/CH4\/O2\/N2\/Ar\/SF6\/CF4\/ CHF3\/C4F8\/NF3\/NH3\/C2F6\/Згідно замовлення (До 12 каналів, без корозійних та токсичних газів) |
H2\/CH4\/O2\/N2\/Ar\/SF6\/CF4\/CHF3\/ C4F8\/NF3\/NH3\/C2F6\/Cl2\/BCl3\/HBr\/ Згідно замовлення(До 12 каналів) |
|||||||
Газова плита |
0~5sccm/50sccm/100sccm/200sccm/300sccm/500sccm/1000sccm/Custom |
||||||||
Завантаження/Розблокування |
Так\/Ні |
Так |
|||||||
Контроль температури вибірки |
10°C~Кімнатна температура/ -30°C~150°C /Custom |
-30°C~200°C/Custom |
|||||||
Зворотне охолодження гелієм |
Так\/Ні |
Так |
|||||||
Облицювання процесної камери |
Так\/Ні |
Так |
|||||||
Контроль температури стінок камери |
Ні/Кімнатна температура-60/120°C |
Кімнатна температура~60/120°C |
|||||||
Система управління |
Автоматичний/власний |
||||||||
Матеріал для етчингу |
На силиконовій основі: Si/SiO2/ SiNx/ SiC..... Органічні матеріали: PR/Органічні фільм...... |
На силиконовій основі: Si/SiO2/SiNx/SiC III-V: InP/GaAs/GaN...... IV-IV: SiC II-VI: CdTe...... Магнітний матеріал\/ сплав матеріалу Металеві матеріали: Ні\/Хр\/Ал\/Мд\/Зо... Органічні матеріали: ОЛ\/Органічна фільма...... Глибоке етуювання силіцю |
|||||||



Авторське право © Гуанчжоу Minder-Hightech Co., Ltd. Всі права захищені