
เทคโนโลยีการกัดเซาะไอออนแบบปฏิกิริยาที่เหนี่ยวนำด้วยขดลวด เป็นหนึ่งในประเภทของ RIE เทคโนโลยีนี้สามารถแยกความหนาแน่นของไอออนพลาสมาออกจากพลังงานไอออนได้ โดยการควบคุมโฟลว์ของไอออนอย่างอิสระ จึงช่วยปรับปรุงความแม่นยำและความยืดหยุ่นในการดำเนินกระบวนการกัดเซาะ
ผลิตภัณฑ์ซีรีส์การกัดไอออนแบบเหนี่ยวนำที่มีความหนาแน่นสูง (ICP-RIE) นั้นพัฒนาบนพื้นฐานของเทคโนโลยีพลาสมาแบบเหนี่ยวนำ เพื่อรองรับความต้องการในการกัดแบบละเอียดและวัสดุเซมิคอนดักเตอร์เชิงประกอบ มีความเสถียรและความแม่นยำในการทำงานสูง เหมาะสำหรับการใช้งานในชิปเซมิคอนดักเตอร์ซิลิกอน อุปกรณ์โฟโตอิเล็กทรอนิกส์ โทรคมนาคมและระบบสารสนเทศ อุปกรณ์พลังงาน และอุปกรณ์ไมโครเวฟ



เหมาะสำหรับวัสดุ:
1. วัสดุที่ทำจากซิลิกัน: ซิลิกอน (Si), ซิลิกาไดออกไซด์ (SiO2), ซิลิกอนไนไตรด์ (SiNx), ซิลิกอนคาร์ไบด์ (SiC)...
2. วัสดุกลุ่ม III-V: อินเดียมฟอสไฟด์ (InP), แกเลียมอาร์เซไนด์ (GaAs), แกเลียมไนไตรด์ (GaN)...
3. วัสดุกลุ่ม II-VI: แคดเมียมเทลลูไรด์ (CdTe)...
4. วัสดุแม่เหล็ก/วัสดุLOY
5. วัสดุโลหะ: อลูมิเนียม (Al), ทองคำ (Au), ทังสเตน (W), ไทเทเนียม (Ti), แทนทาลัม (Ta)...
6. วัสดุอินทรีย์: สารไวแสง (PR), โพลิเมอร์อินทรีย์ (PMMA/HDMS), ฟิล์มบางอินทรีย์...
7. วัสดุเฟอโรอิเล็กทริก/โฟโตอิเล็กทริก: ลิเธียมไนโอเบต (LiNbO3)...
8. วัสดุดายอเล็กทริก: แซฟไฟร์ (Al2O3), ควอตซ์...
การประยุกต์ใช้งานที่เกี่ยวข้อง:
1. การกัดกร่อนแบบเกรติง: ใช้สำหรับการแสดงผลแบบ 3 มิติ อุปกรณ์ไมโครออปติกส์ ออปโตอิเล็กทรอนิกส์ เป็นต้น;
2. การกัดกร่อนเซมิคอนดักเตอร์แบบประกอบ: ใช้สำหรับ LED เลเซอร์ การสื่อสารด้วยแสง เป็นต้น;
3. ซับสเตรตแซฟไฟร์แบบมีลวดลาย (PSS);
4. การกัดกร่อนลิเทียมไนโอเบต (LiNO3): ตัวตรวจจับ ออปโตอิเล็กทรอนิกส์;


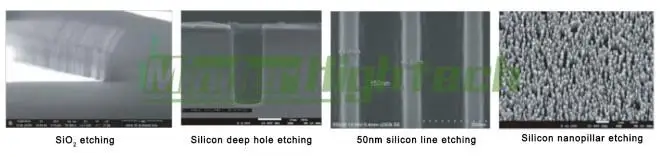
รายการสินค้า |
MD150S-ICP |
MD200S-ICP |
MD150CS-ICP |
MD200CS-ICP |
MD300C-ICP |
||||
ขนาดผลิตภัณฑ์ |
≤6 นิ้ว |
≤8 นิ้ว |
≤6 นิ้ว |
≤8 นิ้ว |
กำหนดเอง≥12นิ้ว |
||||
แหล่งพลังงาน SRF |
0~1000W/2000W/3000W/5000W ปรับได้ อัตโนมัติการจับคู่\,13.56MHz/27MHz |
||||||||
แหล่งพลังงาน BRF |
0~300W/0~500W/0~1000W ปรับได้ อัตโนมัติการจับคู่,2MHz/13.56MHz |
||||||||
ปั๊มโมเลกุล |
ไม่กัดกร่อน : 600 /1300 (ล./ส.) /กำหนดเอง |
ป้องกันการกัดกร่อน:600 /1300 (ล./ส.) /กำหนดเอง |
600/1300(ล./ส.) /กำหนดเอง |
||||||
ปั๊ม Foreline |
ปั๊มกลไก / ปั๊มแห้ง |
ปั๊มแห้งป้องกันการกัดกร่อน |
ปั๊มกลไก / ปั๊มแห้ง |
||||||
ปั๊มสำหรับการสูบเริ่มต้น |
ปั๊มกลไก / ปั๊มแห้ง |
ปั๊มกลไก / ปั๊มแห้ง |
|||||||
แรงดันกระบวนการ |
แรงดันที่ไม่มีการควบคุม / 0-0.1 / 1 / 10Torr แรงดันที่ควบคุมได้ |
||||||||
ประเภทก๊าซ |
H2/CH4/O2/N2/Ar/SF6/CF4/ CHF3/C4F8/NF3/NH3/C2F6/Custom (สูงสุด 12 ช่องทาง ไม่มีแก๊สกัดกร่อนและพิษ) |
H2/CH4/O2/N2/Ar/SF6/CF4/CHF3/ C4F8/NF3/NH3/C2F6/Cl2/BCl3/HBr/ Custom(สูงสุด 12 ช่องทาง) |
|||||||
ระยะการใช้แก๊ส |
0~5sccm/50sccm/100sccm/200sccm/300sccm/500sccm/1000sccm/Custom |
||||||||
โหลดล็อค |
ใช่หรือไม่ |
ใช่ |
|||||||
ควบคุมอุณหภูมิตัวอย่าง |
10°C~อุณหภูมิห้อง / -30°C~150°C / กำหนดเอง |
-30°C~200°C / กำหนดเอง |
|||||||
ระบบทำความเย็นด้วยฮีเลียมแบบย้อนกลับ |
ใช่หรือไม่ |
ใช่ |
|||||||
บุผนังช่องกระบวนการ |
ใช่หรือไม่ |
ใช่ |
|||||||
ควบคุมอุณหภูมิผนังช่อง |
ไม่มี / อุณหภูมิห้อง-60/120°C |
อุณหภูมิห้อง~60/120°C |
|||||||
ระบบควบคุม |
อัตโนมัติ/ปรับแต่งได้ |
||||||||
วัสดุสำหรับการแกะสลัก |
เบสซิลิกอน: Si/SiO2/ SiNx/ SiC..... วัสดุอินทรีย์: PR/อินทรีย์ ฟิล์ม...... |
เบสซิลิกอน: Si/SiO2/SiNx/SiC กลุ่ม III-V: InP/GaAs/GaN...... IV-IV: SiC กลุ่ม II-VI: CdTe...... วัสดุแม่เหล็ก / วัสดุLOY วัสดุโลหะ: Ni\/Cr\/Al\/Cu\/Au... วัสดุอินทรีย์: PR\/ฟิล์มอินทรีย์...... การกัดซิลิกอนแบบลึก |
|||||||



ลิขสิทธิ์ © Guangzhou Minder-Hightech Co.,Ltd. สงวนลิขสิทธิ์