
Inductively coupled reactive ion etching տեխնոլոգիան RIE-ի տեսակ է: Այս տեխնոլոգիան իրականացնում է պլազմային իոնների խտության և իոնների էներգիայի անջատումը՝ անկախ կերպով կառավարելով իոնային հոսքը, որի շնորհիվ բարելավվում է փորման գործընթացի ճշգրտությունը և ճկունությունը:
Բարձր խտության ինդուկտիվ զուգահեռ ռեակցիոն իոնային փորման (ICP-RIE) շարքի ապրանքները հիմնված են ինդուկտիվ կապակցված պլազմային տեխնոլոգիայի վրա և նախատեսված են ճշգրիտ փորման և բարդ կիսահաղորդիչների փորման կարիքների համար: Այն ունի հ excellent երկարաժամկետ կայունություն և գործընթացի կրկնելիություն, և հարմար է կիրառման համար սիլիցիումե կիսահաղորդիչներում, օպտոէլեկտրոնիկայում, տեղեկատվության և կապի միջոցներում, էներգետիկ սարքերում և միկրոալիքային սարքերում:



Կիրառելի նյութեր.
1. Սիլիցիումի հիմքով նյութեր՝ սիլիցիում (Si), սիլիցիումի երկօքսիդ (SiO2), սիլիցիումի նիտրիդ (SiNx), սիլիցիումի կարբիդ (SiC)...
2. III-V նյութեր՝ ինդիումի ֆոսֆիդ (InP), գալիումի արսենիդ (GaAs), գալիումի նիտրիդ (GaN)...
3. II-VI նյութեր՝ կադմիումի տելուրիդ (CdTe)...
4. Մագնիսական նյութեր/ալյուր նյութեր
5. Մետաղական նյութեր՝ ալյումին (Al), ոսկի (Au), վոլֆրամ (W), տիտան (Ti), տանտալ (Ta)...
6. Օրգանական նյութեր՝ ֆոտոշիթական նյութ (PR), օրգանական պոլիմեր (PMMA/HDMS), օրգանական բարակ թիթեղ...
7. Ֆերոէլեկտրիկ/լուսաէլեկտրական նյութեր՝ լիթիումի նիոբատ (LiNbO3)...
8. Դիէլեկտրիկ նյութեր՝ սապֆիր (Al2O3), քվարց...
Կապված կիրառումներ:
1. Տարաների փորագրում՝ օգտագործվում է 3D դիսպլեյների, միկրոօպտիկական սարքերի, օպտոէլեկտրոնիկայի և այլնի համար.
2. Կիսահաղորդիչների փորագրում՝ օգտագործվում է LED-ների, լազերների, օպտիկական կապի և այլնի համար.
3. Նախշային սաֆիրե ստորաշերտ (PSS).
4. Լիթիումի նիոբատի (LiNO3) փորագրում՝ դետեկտորներ, օպտոէլեկտրոնիկա.


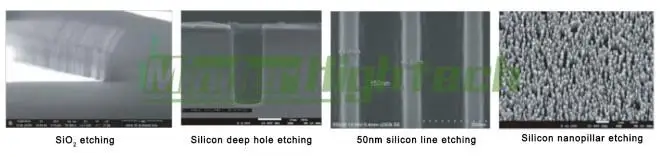
Պաշտոն |
MD150S-ICP |
MD200S-ICP |
MD150CS-ICP |
MD200CS-ICP |
MD300C-ICP |
||||
Ապրանքի չափը |
≤6 դյույմ |
≤8 դյույմ |
≤6 դյույմ |
≤8 դյույմ |
Ավելացված≥12դյույմ |
||||
SRF էներգիական 源源 |
0~1000Վ/2000Վ/3000Վ/5000Վ կարգավորելի, ավտոմատ համապատասխանություն\,13.56MHz/27MHz |
||||||||
BRF էներգիական 源源 |
0~300Վ/0~500Վ/0~1000Վ կարգավորելի, ավտոմատ համապատասխանություն,2MHz/13.56MHz |
||||||||
Մոլեկուլային գազատրոս |
Ոչ կորոզիոն : 600 /1300 (Լ/ս) /Ավելացված |
Կորոզիայի դիմադրություն: 600 /1300 (Լ/ս) /Ավելացված |
600/1300(Լ/ս) /Ավելացված |
||||||
Սկիզբնական գազատրոս |
Մեխանիկական кач / չնարույց кач |
Հաղորդագրությունը չնարույց кач |
Մեխանիկական кач / չնարույց кач |
||||||
Սկիզբնական кач кач |
Մեխանիկական кач / չնարույց кач |
Մեխանիկական кач / չնարույց кач |
|||||||
Պրոցեսի ճնշում |
Անվարկած ճնշում / 0-0.1 / 1/10Torr վարկած ճնշում |
||||||||
Գազի տեսակ |
Հ2 / Չ4 / Օ2 / Ն2 / Ար / ՍՖ6 / ԿՖ4 / ՉՖ3 / Կ4Ֆ8 / ՆՖ3 / ՆՀ3 / Կ2Ֆ6 / Պատվերական (Ենթարկվող է 12 հանգուլիների, ոչ կորոզիային և տոքսիկ գազ) |
Հ2 / Չ4 / Օ2 / Ն2 / Ար / ՍՖ6 / ԿՖ4 / ՉՖ3 / Կ4Ֆ8 / ՆՖ3 / ՆՀ3 / Կ2Ֆ6 / Կլ2 / ԲԿլ3 / ՀԲր / Պատվերական (Ենթարկվող է 12 հանգուլիների) |
|||||||
Գազային միջակայք |
0~5sccm/50sccm/100sccm/200sccm/300sccm/500sccm/1000sccm/Դարձնել |
||||||||
Բեռնացում/Արտահանում |
Այո/Ոչ |
(YES) ԱՅՈՒ actionTypes |
|||||||
Նմանակի ջերմաստիճանի կառավարում |
10°C~Սենսացիականտեմ/ -30°C~150°C /Դարձնել |
-30°C~200°C/Դարձնել |
|||||||
Հելիումի հետ կուլինգ |
Այո/Ոչ |
(YES) ԱՅՈՒ actionTypes |
|||||||
Պրոցեսի բարձրության գաղափարական գործողություն |
Այո/Ոչ |
(YES) ԱՅՈՒ actionTypes |
|||||||
Բարձրության պատահանդերի ջերմաստիճանի կառավարում |
Ոչ/Սենսացիականտեմ-60/120°C |
Տանbour ջերմությունը ~60\/120°C |
|||||||
Կառավարման համակարգ |
Ավտոմատ/սեփական |
||||||||
Եթելում նյութ |
Սիլիցոն հիմք՝ Si\/SiO2\/ SiNx\/ SiC..... Օրգանիկ նյութեր՝ PR\/Օրգանիկ ֆիլմ...... |
Սիլիցոն հիմք՝ Si\/SiO2\/SiNx\/SiC Երրորդ-հինգերոստ՝ InP\/GaAs\/GaN...... IV-IV: SiC II-VI: CdTe...... Մագնիսական նյութ՝ դրամական նյութ Courier Metallic materials: Ni/Cr/Al/Cu/Au... Organic materials: PR/Organic film...... Սիլիցիումի խոր գետավորում |
|||||||



权 © Գյուանգզու Մինդեր-Հայտեխ Կո.,Լտդ. Բոլոր իրավունքները պաշտպանված են